磁控溅射法制备薄膜材料实验报告
实验一 磁控溅射法制备薄膜材料
一、实验目的
1、详细掌握磁控溅射制备薄膜的原理和实验程序;
2、制备出一种金属膜,如金属铜膜;
3、测量制备金属膜的电学性能和光学性能;
4、掌握实验数据处理和分析方法,并能利用 Origin 绘图软件对实验数据进行处理和分析。
二、实验仪器
磁控溅射镀膜机一套、万用电表一架、紫外可见分光光度计一台;玻璃基片、金属铜靶、氩气等实验耗材。
三、实验原理
1、磁控溅射镀膜原理
(1)辉光放电
溅射是建立在气体辉光放电的基础上,辉光放电是只在真空度约为几帕的稀薄气体中,两个电极之间加上电压时产生的一种气体放电现象。辉光放电时,两个电极间的电压和电流关系关系不能用简单的欧姆定律来描述,以气压为 1.33Pa 的 Ne 为例,其关系如图 5 -1 所示。
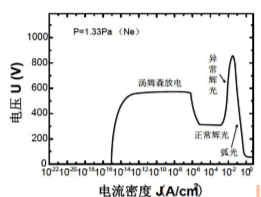
图 5-1 气体直流辉光放电的形成
当两个电极加上一个直流电压后,由于宇宙射线产生的游离离子和电子有限,开始时只有很小的溅射电流。随着电压的升高,带电离子和电子获得足够能量,与中性气体分子碰撞产生电离,使电流逐步提高,但是电压受到电源的高输出阻抗限制而为一常数,该区域称为“汤姆森放电”区。一旦产生了足够多的离子和电子后,放电达到自持,气体开始起辉,出现电压降低。进一步增加电源功率,电压维持不变,电流平稳增加,该区称为“正常辉光放电”区。当离子轰击覆盖了整个阴极表面后,继续增加电源功率,可同时提 高放电区内的电压和电流密度,形成均匀稳定的“异常辉光放电”,这个放电区就是通常使用的溅射区域。随后继续增加电压,当电流密度增加到~0.1A/cm 2时,电压开始急剧降低,出现低电压大电流的弧光放电,这在溅射中应力求避免。
(2)溅射
通常溅射所用的工作气体是纯氩,辉光放电时,电子在电场的作用下加速飞向基片的过程中与氩原子发生碰撞,电离出大量的氩离子和电子,电子飞向基片。氩离子在电场的作用下加速轰击靶材,溅射出大量的靶材原子,这些被溅射出来的原子具有一定的动能,并会沿着一定的方向射向衬底,从而被吸附在衬底上沉积成膜。这就是简单的“二级直流溅射”。
(3)磁控溅射
通常的溅射方法,溅射沉积效率不高。为了提高溅射效率,经常采用磁控溅射的方法。磁控溅射的目的是增加气体的离化效率,其基本原理是在靶面上建立垂直与电场的一个环形封闭磁场,将电子约束在靶材表面附近,延长其在等离子体中的运动轨迹,提高它参与气体分子碰撞和电离过程的几率,从而显著提高溅射效率和沉积速率,同时也大大提高靶材的利用率。其基本原理示意见图 5-2。

图 5-2 磁控溅射镀膜原理
磁控溅射能极大地提高薄膜的沉积速度,改善薄膜的性能。这是由于在磁控溅射时气体压力减小了,使薄膜中嵌入的气体杂质减少,薄膜表面气孔减少而密实,膜面均匀一致。
磁控溅射可以分为直流磁控溅射和射频磁控溅射,射频磁控溅射中,射频电源的频率通常在 5~ 30MHz。溅射过程中还可以同时通入少量活性气体(如氧气),使它和靶材原子在基片上形成化合物薄膜 (氧化物薄膜),这就是反应溅射。
2、溅射装备
以平面溅射方式为例,如图 5-3 所示的溅射装置图。在真空室中,基片与圆形靶表面正对且用带孔挡 板隔开,其中阴极靶用循环水冷却,基片架上附有加热或通冷却水装置。

四、实验内容
1、在教师指导下学生查阅有关文献,了解磁控溅射制备薄膜的原理;
2、 在教师指导下,学习磁控溅射镀膜机的正确使用;
3、在教师指导下,按照实验程序进行薄膜制备实验;
1)、开相关设备的电源,并开冷却水和空压机;
2)、打开放气阀,待没有气压声时打开真空室大门;
3)、把玻璃样品安放在靶台的适当位置,关闭真空室大门;
4)、关闭放气阀,打开机械泵控制电源,然后打开旁抽阀,开始抽真空,直到真空度低于5Pa;
5)、关闭旁抽阀,打开前级阀,开分子泵电源,逐渐打开翻板阀,开始抽真空,此时分子泵的转速为8400r/s,频率为135Hz。当真空度为3×10-3Pa时,分子泵转速为2700r/s,频率为450Hz,电压55V,电流3.3A;
6)、打开氩气瓶和对应的MCF控制阀,MCF流量显示仪打到阀控位置,然后调节流量为20SCCM(即标况下20mL/min),此时真空室气压为5.5×10-2Pa缓慢调节翻板阀开口的大小,调节真空室气压至1到2Pa之间(本实验为1.6Pa);
7)、打靶台挡板开直流电源开关,调节功率,可以观察到,当为10W左右时,开始出现辉光,并且辉光呈绿色,并随功率的增大颜色变亮;
8)、开样品挡板开始溅射;
9)、停止溅射:将功率逐渐调制0,并关闭溅射电源,关闭氩气瓶和对应的MCF控制阀;关闭翻板阀,关闭分子泵电源,直到分子泵频率和转速都降为0时,关闭前级阀;关闭机械泵;
10)、开放气阀,直至没有气流声,然后打开真空室大门,取出样品,可观察到玻璃样品上已镀上一层银白色的膜。
11)、关闭真空室并将其抽至低真空,然后关闭空压机、水冷系统等,并切断总电源。
4、在教师指导下测量薄膜的电学和光学性质;
5、对薄膜性能进行分析;
6、总结实验结果,撰写实验报告。
五、实验数据与数据处理
在实验中,老师对电镀薄膜进行了时间控制,时间分别控制在10s和60s。这两种的放射率测量的结果如下图:
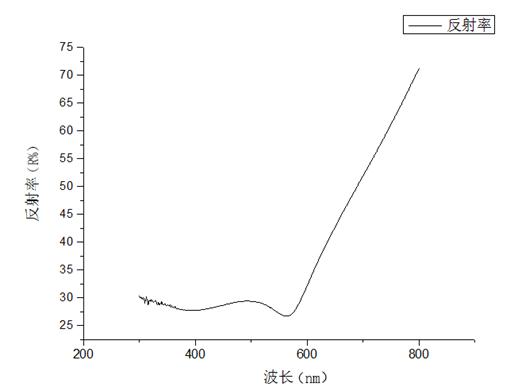
电镀10秒的薄膜

电镀60秒的薄膜
六、实验结论
从上面两幅波长与反射率的关系可以看出:
1、对于电镀10秒的薄膜,在波长300-600(基本上是可见光)间随着波长的变长,反射率并没有明显变化,都比较低,在波长600mm(基本是红外光)之后,随着波长的加长反射率逐渐增加。可以知道,较薄的膜对波长短的光透过率低。
2、对于电镀60秒的薄膜,从波长300mm开始,随着波长的加长反射率基本呈线性增加。3、对于10秒和60秒两个薄膜来说,电镀60秒的薄膜其反射率远高于电镀10秒的薄膜。
3、在可见光范围下,10秒的呈透明,而60秒的几乎不透明。
七、思考题
1、在镀膜机使用过程中,你知道哪些注意事项?
答:(1)要确定真空室内的膜料、离子源灯丝、工件架是否按要求放置好。
(2)工艺完成后要关闭电子枪和离子源等开关,待真空镀膜设备冷却一消失后方可关闭电源。
(3)允许不可开店电柜、真空室的屏蔽门。
2、直流磁控溅射镀膜有哪些特点,有利于哪些薄膜材料的制备,而哪些材料用直流磁控溅射制备不利?
答: 溅射镀膜是利用气体放电产生的正离了在电场的作用下高速轰击作为阳极的靶,使靶材料中原子(或离子)逸出而淀积到被镀基片表面,从而形成所需要的薄。溅射镀膜类型很多,与真空蒸发镀膜相比,其主要特点有下面四点:
(1)任何物质都可以溅射,尤其是高熔点、低蒸汽压的元素和化合物;
(2)溅射薄膜与基片之间的附着性好;
(3)溅射薄膜密度高、针孔少、薄膜纯度高;
(4)溅射薄膜膜厚容易控制,重复性好;
具有磁性的材料,半导体等不适合磁控溅射,没有磁性的材料比较适合。
3、 你制备的金属膜的光学和电学性能与你查到的该类薄膜的性能有什么不同,为什么?
答:网上显示的真空磁控溅射镀膜的性能:电阻率低,透射率高。
实验制备的金属膜的性能:电阻率略高,透射率偏低。
原因:实验中温度偏高,导致晶粒过大,电阻率升高;时间过长同样会导致温度增高,晶粒变大,电阻率升高;氩气气压过高,氩离子过多,碰撞多,晶化率变低,透射率变低;靶基距离过大,散射增大,致密性下降,透射率变低。
第二篇:ZnO薄膜的磁控溅射法制备及其性质研究
中山大学
硕士学位论文
ZnO薄膜和p型ZnO薄膜的磁控溅射法制备及其性质研究
姓名:赵银平
申请学位级别:硕士
专业:光学
指导教师:汪河洲
20060501
摘要
ZnO是一种新型的宽禁带化合物半导体材料,其室温禁带宽度为3.37eV,熔点为2230K,具有良好的热稳定性和化学稳定性以及更短的激射波长,是制作短波长激光器以及紫外探测器的理想材料。ZnO最大的优点是其高的激子束缚能(60meV),比同是II一Ⅵ族的ZnSe(2lmeV)及III—V族GaN(20meV)高出许多,高的激子束缚能使其在室温下具有强的激子发光特性。
本论文利用射频磁控反应溅射技术生长出具有高度晶面(002)取向的ZnO外延薄膜。通过原子力显微镜(AFM)、X射线衍射(XRD)、吸收光谱(ABS)和荧光光谱(PL)等测量分析手段,分别研究分析了不同衬底、不同溅射气氛和退火对ZnO薄膜结晶质量及光学性质的影响。研究表明,在200℃低温生长的硅基ZnO外延薄膜能够形成几十到几百纳米的氧化锌准六角结构外形,而玻璃基底上则没有。当氧氩比为4:1时,吸收谱激子峰最佳;而退火处理后,所有样品的结晶质量提高,表面更平整,且吸收谱的激子峰(363ram)得到加强,同时出现了402nm的晶体内本征氧空位的紫光发射。
P型掺杂是形成p-n结,实现ZnO电注入发光的关键技术。本论文应用磁控溅射的方法,首次采用“高掺磷Si衬底-ZnO薄膜磷扩散法”制备了P型ZnO薄膜。XRD测试结果显示了P型ZnO薄膜的高度C轴择优取向,其结晶尺寸大约18nm。P型ZnO薄膜与n型Si衬底之间的异质p—n结具有开启电压为2.5V、较低的反向漏电电流的良好的伏安特性曲线。关键词:ZnO薄膜,P型ZnO薄膜,射频磁控溅射,反应溅射,光致发光
ABSTRACT
ZnOisanovelwide—gapsemiconductor,whichhasabandgapof3.37eV,combiningwithhighexcitonicgainandlargeexcitonbinding
aenergy(60meV).ItissuitablecandidatefortheUVoptoelectronicdeviceapplications.
Inthispaper,lowtemperatureepitaxialgrowthofhighlyc-axis(0002)orientedZnOthinfilmswereachieved
reactiveradioonn-Si(001)andquartzglasssubstratesseparatelybyfrequency(RDmagnetoCO—sputteringtechnique,ThepropertiesofthesampleswerestudiedbyX-raydiffraction(XRD),atomicforcemicroscopy(AFM),absorption
structurespectroscopy(ABS)andphotoluminescence(PL).ItopticalpropertiesofZnOthinfilmsareisfoundthattheandinfluencedbythesputteringatmosphereandtheannealprocedure.Aquasi-hexagonalstructureofZnOthinfilmis
onobservedbyAFMwhenitWaSdeposited
butnotonn-Si(001)substrateatlowtemperature,glasssubstrates.Thestrongestexcitonpeakintheabsorptionspectrum
attheratio(ABS)appearsof4:1(02/Arratio).Afterannealingtreatment,the
surfacemorphologyandthefilmqualityofallthesampleswereimprovedobviously,
nativedonorthereforetheexcitonpeak(363nm)wasenhanced,and
wasobservedaccordingly.
adefects(Vo)luminescenceof402urnP—typedopingofZnOis
electriccurrent
OnkeysteptOobtainp-njunctionsandtOrealizetheinjectedemissionofUV-emittingdiode.P—typeZnOwerepreparedn+一typesingle?crystalSi(100)(phosphordoped)substrateusingRFmagnetoCO—sputteringtechnique.Thecrystalstructureoftheobtainedp—ZnOwerebyX-raydiffraction.Theexaminedcurrent-voltage(,一功characteristicsderivedfromthephosphor(P)dopedZnO/PdopedSitwo—layerstmctureclearlyshowtherectifyingcharacteristicsoftypicalP一"junctions.TheI—Vcharacteristicsderivedfromsuch
astructureexhibitclearlyrectifcationcharacteristics,whichimplies
fabricateZnO—basedoptoelectronicdevicessuch
6ln】re.aspossibilitytonearLEDsandLDsinthe
Keywords:ZnOthinfilm,p-typeZnOthinfilm,Reactivesputtering,RFmagneticco‘sputtering,
Photoluminescence.TI
第1章绪论
1.1引言
新世纪是以高科技为基础的新经济时代,而在高科技的发展中,新材料是支柱、动力和先导,尤其是半导体材料工业,它是半个多世纪发展起来的新兴产业,依仗半导体技术这一高新技术的发展,以其惊人的速度改变了世界的各个方面。因此,半导体材料无论是从研究和应用方面都具有十分诱人的发展前景。
ZnO是一种应用广泛的多功能半导体材料。在透明电极、体声波器件(BAW)、表面声波器件(SAw)、压敏电阻、湿敏、气敏传感器和太阳能电池等领域内均有着广泛的应用。
ZnO薄膜是透明的导电薄膜,由于其较高的禁带宽度而显示出在紫外截止、可见光高透明、红外区的高度反射及较低的电阻率等特性。这些特性决定其在太阳能电池、显示器等诸多方面有着十分广阔的应用。目前,大屏幕、高清晰度液晶显示普及迅速,其需求不断增加,而全世界性的能源匮乏和自然环境保护的需要也展现了太阳能电池的良好发展前景,这就为透明导电氧化物提供了机遇和发展空间。
近年来,随着短波光电子器件的巨大潜在应用,宽带半导体材料的研究越来越受到人们的重视。GaN基短波光电子器件的产业化的同时,ZnO的研究也越来越收到人们的重视。ZnO薄膜作为蓝宝石衬底上生长GaN薄膜的缓冲层”,2】,具有与OaN薄膜的晶格失配度小,热膨胀系数差异小的优点。为提高氮化物器件的性能,Zn0是最有希望的异质外延衬底。
Zn0作为宽禁带半导体材料,本身极有希望开发出短波段的光电子器件,如UV探测器、LED、LD等,由于近年来基于宽禁带半导体材料的短波长激光器及探测器引起了人们越来越多的关注,随着III-V族GaN蓝光激光器以及II一Ⅵ族ZnSe蓝绿激光器的研制成功为实现高密度光存储提供了广阔的应用前景。与此
同时,寻找激射波长更短,性能更稳定的紫外光电材料也成为目前研究的热点。宽禁带半导体Zn0由于其优越的光电特性引起了众多研究机构的关注。1.2Zn0的结构及其特性
1.2.1Zn0的结构
Zn0晶体属于六方晶系6mm点群,具有六角纤锌矿晶格结构,其密度为5.67mg/cm3,晶格常数是:a=0.3249nm,c-0.52056nm,c/a=1.60。(如图1一L)
a
图l—lZn0的晶体结构
在纤锌矿ZnO晶体中,锌(Zn)、氧(O)各自组成一个六方密堆积的子格子,这两个子格子可形成复格子结构。每个zn原子和最近邻的四个原子也构成一个四面体结构,同样,每个O原子和最近邻的四个原子也构成一个四面体结构。0;过,每个原子周围都不是严格四面体堆成的,在c轴方向上,Zn原子与O原子之问的距离0.196nm,在其他原子之间的问距稍微小一些。此外,由于zn和O的电负性差别比较大,zn.O键基本上是极性的。ZnO纤锌矿结构,其能量问隔和品格常数与GaN非常接近,作为GaN外延的单晶衬底有效的减小品格失配度。
1.2.2ZnO薄膜中的本征点缺陷的形成及其作用
在生长或实验所能达到的锌氧的分压强下,一般生成的单晶ZnO总是被发现含有过剩的锌同时欠缺氧口】。这样从实验得出的结论是:晶体ZnO总是含有间隙锌和氧空位这两种缺陷,至于哪一种占突出地位,有着不同的说法。如果从离子扩散和缺陷大小来考虑,则间隙锌是主要的缺陷13J。另一些作者,则根据反应速率【4】、扩散实验[5l、电导率与霍耳效应实验‘61认为氧空位是主要的缺陷。但最终还是要从理论上给予说明。最近的理论计算171采用了第一原理的(thefirstprinciple)平面波赝势逼近法对ZnO中本征点缺陷的电学结构、原子几何结构以及形成能进行了分析,在这种综合的分析下得到的缺陷形成能是较为可靠的。
ZnO中的本征点缺陷共有6种形态:(1)氧空位V。:(2)锌空位Vz。;(3)反位氧(即锌位氧)0z。;(4)反位锌(即氧位锌)Zno;(5)间隙位氧0。;(6)间隙位锌zni。在纤锌矿结构中含有两种间隙位:四面体配位(tet)和八面体配位(otc)。图1—2(a)是3种本征缺陷的形成能随费米能级的位置不同而变化的曲线,计算时是假设富锌的情况。图l一2(b)是另3种本征缺陷的形成能随费米能级的位置不同而变化的曲线,计算时是假设富氧的情况。缺陷形成能的斜率表明了电荷态,如果斜率有了变化,则说明由一个电荷态跃变到了另一个电荷态。形成能低表明易形成相应的缺陷。由图1—2(a)不难看出,对于一般的费米能级位置较高的n型ZnO,最易产生的缺陷是氧空位和锌空位,其次是八面体配位的间隙锌。而对于费米能级较低的P型ZnO,由图1—2(b)可以看出,最易产生的缺陷则是锌空位与反位氧。
由于原生ZnO一般都显示出为n型,所以有必要对n型ZnO中的施主与受主缺陷以及它们之间的补偿进行分析。图1—2已经表明,在n型ZnO中,中性电荷态的氧空位V。以及负二价电荷态锌空位Vz。。2有较低的形成能。其中V。是负二价占位的,可提供两个电子,是一种二价的施主;而Vz。’2既不是施主也不是受主。中性电荷态的间隙Zni(otc)是一种二价施主,虽然根据计算它的形成能达到1.8eV,远大于氧空位的形成能,不太容易形成,但Vanheusden等证实在n型ZnO样品中自由载流子浓度n远大于氧空位的浓度【8J,因此他们推断zn,是一种施主。Look等人用高能电子辐射实验证明Zni是浅施主,其能
级位于导带下30meV[91。Ferm.1evelleVFermIleve№V
图1—2高锌和富氧情况下ZnO中几种缺陷的形成能随费米能级的变化
(图中费米能级为零对应价带顶,形成能为负表明离解)
早期的电子顺磁共振实验已经证实V。足一种深施主【101,但是变温霍耳实验…】证实ZnO有两个浅施主能级,分别位于导带底3lmeV和61meV,其载流子浓度分别为1×1016cm。和1×10”cm一。3lmeV的能级可看作是Zn、浅施主,而61meV能级在Reyonlds等人…l的PL实验中被证明属于中性施主。它当属于中性电荷态氧空位V。。因此,可认为V。有一深一浅两个能级。根据图1.2,反位锌缺陷zIl0的形成能比Zni稍高一点,为2.4eV左右。中性电荷态的zno是叫价占位,可接纳4个电子,为四价受主。但是zn0“和Z110“的形成能很大,不大可能产生【”,因此可认为zn。是二价受主。在现有文献中,我们没有查到Z110的能级位置。但是根据Reynolds等关于ZnO中绿带产生的模型【l“,质量较好的ZnO薄膜中只有一种受主,其位置处于导带以下2.38eV,即价带顶以上O.96eV。结合上而关于形成能的理论分析,有理由认为它对应着zn0的能级位置。
ZnO薄膜中的自补偿是在以上3种施主和受主之问进行的。由于中性电荷态的氧空位V。形成能仅有0.02eV,远小于zn,和zn。的形成能1.8eV和2.4eV,因此可以认为,在质量较好的原生ZnO薄膜中,V。是最重要的施主及补偿度的来源;实验也证实v。的浓度比zn.的浓度大约高一个数量级ll“。但由于zn,的能级只位于导带下30meV,接近于室温的kT=26meV,比V。能级的6lmeV小一倍,所以在室温下,ZnO薄膜的导电特性主要来自Zn.施主。
I.2.3ZnO薄膜的材料特性
ZnO是一种的II一Ⅵ族宽禁带化合物半导体材料,其直接禁带宽度为3.37eV;ZnO晶体的晶格常数a=O.3249nm,c=O.52056nm,与GaN的晶格常数非常相近;此外,ZnO薄膜还具有以下优异的性质:
(1)ZnO薄膜的光电性质
ZnO是一种宽禁带的n型半导体材料,具有优良的光电性质。其光电性质与化学组成、能带结构、氧空位数量及结晶程度密切相关‘”I。在适当的制备条件及掺杂下,ZnO薄膜表现出很好的低阻特征。B.Joseph等人【14】利用化学喷雾沉积法在沉积温度为723K及真空煅烧的条件下,制得厚度为175nm的未掺杂ZnO薄膜的电阻率仅为3×lO刁Q?em,而T.Schuler等[15】以sol—gel法制备的厚度为174nm的掺Al等杂质的ZnO的电阻率也仅为5×1000?cm。研究表明,定向透明的ZnO薄膜以及Al、In等掺杂的ZnO薄膜具有优异的光电性质。S.H.Bac等I“1人利用激光脉冲沉积法在蓝宝石基片上制得的ZnO薄膜具有绿一黄色光发光性质。研究表明,ZnO薄膜的紫外光发光强度随结晶度的增加而增加。当沉积的基片温度为600。C,氧分压为200mTorr时,制得高质量的ZnO薄膜能发射强的紫外光。许多研究表明,通过掺入A1等元素可以对ZnO薄膜的禁带宽度加以调节。SiIra在ZnO薄膜中掺入适量的Al,使其禁带宽度显著增大1171。这种ZnO薄膜具有较高的光透过率,在可见光区,光透过率接近90%。(2)ZnO薄膜的压电性质
高密度、定向生长的ZnO薄膜具有良好的压电性质,如高机电耦合系数和低介电常数。N.K.Zayer等[18I研究表明,利用射频磁控溅射法在200。C的Si基片上沉积的c轴择优取向的ZnO薄膜具有很好的压电性,其在0.9GHz附近的高频区表现出很好的压电转换效应及低嵌入损耗(4.9dB)等特征,是制备高频纤维声光器件如声光调制器等压电转换器材料。
(3)ZnO薄膜的气敏性质
ZnO薄膜是一种气敏材料,其经某些元素掺杂之后对有害气体、可燃性气体、有机蒸汽等具有很好的敏感性,可制成各种气敏传感器。未掺杂的ZnO对
还原性、氧化性气体具有敏感性;掺Pb、Pt的ZnO对可燃性气体具有敏感性;掺Bi203、Cr203、Y203等的ZnO薄膜对H2具有敏感性;掺La203、Pb或V205的ZnO对酒精、丙酮等气体表现出良好的敏感性,用其制备的传感器可用于健康检测、监测人的血液酒精浓度以及监测大气中的酒精浓度等等。
ZnO室温带隙宽度为3.37eV,具有很高的化学稳定性和热稳定性,在大气中不易被氧化。与III—V族氮化物和II一Ⅵ族硒化物相比,ZnO材料的稳定性是其维半导体(量子阱、量子线、量子点)均高出许多,表明ZnO激子具有很好的稳定性,这对于实现室温运转的低闽值短波长激光器而言非常有利。另外,ZnO稳定性和使用寿命。
1.3ZnO薄膜的应用
(1)紫外探测器利用ZnO的宽禁带和高光电导特性,可制作紫外探测的产生过程及氧吸收和光解析过程。对玻璃衬底上沉积的ZnO薄膜的研究表明,
(2)LDZnO激子束缚能为60meV,是GaN的2倍,室温下并不离化,而在高密度3倍频YAG:Nd的353nm脉冲激光激发下,可以产生紫外受激发射。用激
(3)太阳能电池ZnO薄膜尤其是ZnO:Al薄膜,具有优异的透明导电性能。无法比拟的。ZnO的内聚能和熔点均很高,表明其具有很强的结合能力。同时,ZnO的激子束缚能为60meV,比GaN(21meV)、ZnSe(20meV)和一般的低是II一Ⅵ族化合物半导体材料中最“硬”的材料之一,因此,在ZnO基器件的运转过程中不会因为升温而产生缺陷的大量增殖。从而将会极大提高期间的温度器。早期的研究表明,ZnO的光反应包括快速和慢速两个过程:电子一空穴对后者起主要作用‘191。H.Fabricius等人利用溅射的ZnO薄膜制作出上升时问和下降时间分别为20¨s和30p,s的光探测器。而L.Ying等人利用MOCVD生长的ZnO薄膜制作出上升时IhJ*lJ下降时间分别为lgs和的1.59s的紫外光探测器,大大提高了器件的质量。子复合来代替电子一空穴对的复合,可使受激发射的闽值降至240kW/cm2,激子发射温度可达550。C,而目.单色性很好‘201。
ZnO薄膜主要是作为透明电极和窗口材料用于太阳能电池,ZnO受到高能粒子辐射损伤较小,因此特别适合于太空中使用【2”。
(4)光电器件ZnO在400~2000nm甚至更长的波长范围内都是透明的,加之所具有的电光、压电等效应,成为集成光电器件中一种极具潜力材料。采用si晶片作衬底,在其上生长的ZnO薄膜材料,可提供一种将电学、光学,以及声学器件进行单片集成的途径,而这些正是LiNb03声光器件所缺少的。这种集成方法还有其它许多常规材料所无法比拟的优越性,如可以利用成熟的Si平面工艺,将光源、探测器、调制器、光波导及相关电路等进行单片集成,适合于大规模、低成本、生产具有小型化、高稳定性的光电集成电路。另外,研究人员发现在掺Li的ZnO薄膜中zn原子被Li原子所取代,因而在适当的温度和组成下,材料具有强介电特性,这个发现使ZnO薄膜在集成铁电器件中也具有潜在的应用前景。
(5)可与GaN互作缓冲层ZnO作为缓冲层和衬底也得到有效应用11一,尤其在GaN的研究中口2。51,由于晶格失配,要生长高质量的GaN材料及其合金如工n1.。GaxN,A11.xGaxN还是有相当大的难度,而缓冲层可以为GaN外延生长提供一个平整的成核表面,从而获得优质的GaN薄膜。ZnO作为缓冲层有很多优点:一方面,ZnO与GaN具有相似的晶格特性。a轴方向失配度为1.9%,c轴方向仅为O.4%,利用ZnO作为衬底或缓冲层可获得高质量的GaN薄膜,尤其是C轴择优取向的ZnO薄膜[23,25];另一方面,ZnO薄膜的n型掺杂,使其具有良好的电学特性,用其作衬底或缓冲层比用其它材料好得多;而且,有些应用中,通过对ZnO的选择性腐蚀,可以实现Gah层与衬底的分离【26J。因此为提高氮化物器件的性能,ZnO是最有希望的异质外延衬底。
(6)制作声表面波器件ZnO薄膜作为一种压电材料,它以其所具有较高的机电耦合系数和低介电常数,使其在超声换能器、Bragg偏转器、频谱分析器、高频滤波器、高速光开关及微机械上有相当广泛的用途。这些器件在大存量、高速率光纤通信的波分复用、光纤相位调制、反雷达动态测频、电子侦听、卫星移动通信、并行光信息处理等民用及军事领域的应用也非常广泛。随着通信技术的发展及通信流量的增加,在较低频率通信已趋饱和,使得通信频率向
高频发展,同时移动通信也要求具有更高的频率。在高于1.5GHZ的频率范围内,具有低损耗的高频滤波器成为移动通信系统的最关键部件之一。而ZnO薄膜是制作这种高频表面声波器件的首选材料。目前,日本村田公司己在蓝宝石衬底上外延Zn0薄膜制作出低损耗的1.5GHz的射频SAW滤波器,目前难在研究开发2GHZ的产品。
ZnO薄膜具有良好的压电性能,用作压电换能器和表面声波器件(SAW),有很高的机电耦合系数。利用气体分子在薄膜表面的吸附~解析性质,ZnO还可用来制造气敏和湿敏传感器等。Zn0薄膜以其性能多样、应用广泛和价格低廉等突出优势,又因其制备方法多样、工艺相对简单、易于掺杂改性与硅IC兼容,有利于现代器件的集成化,代表着现代材料的发展方向,是一种在高新技术领域及广阔的民用和军事领域极具发展潜力的薄膜材料。可见,ZnO薄膜有一定的潜在市场和良好的产业化前景。随着研究工作的不断深入,ZnO薄膜的技术应用必将不断渗透到众多领域并影响社会生产和人们的生活。囡此,对Zn0薄膜的深入研究具有极其重要的意义。
1.4ZnO薄膜的研究现状
总的来说,目前在国内外,n型薄膜材料已得到广泛和较深入的研究,P型薄膜材料的研究也已经较全面的展开,但其质量还远不及n型的,同质p-n结的研究还不够多,发光效果还很不理想。
1.4.1n型ZnO薄膜的研究
为了调节薄膜的光电性能,人们对ZnO薄膜进行了n型掺杂。常用的掺杂元素是B、AI、Ga、In、Sc、Si、Sn和F等。目前。n型ZnO薄膜已经具有相当优异的性能,如载流子浓度可达1019~1021cm~,电阻率可达10‘3~10—5Q?cm,霍耳迁移率u。为10.O~135.0cm2/V?S,表征c轴取向的(002)面x射线衍射谱线的半高宽(XRDFWHM)一般为O.1~O.5。。国内成功地制备了品质优良的Zn0
薄膜的报道也相当多f27-29]。总体来说,薄膜c轴取向良好,带边激子符复合紫外辐射强度较高,可见光透过率≥85%。最近,通过对氧氩气流量的调节人们在低温(如200℃)衬底上制备了颗粒线度较大(如200nm)的高质量ZnO薄膜[30l。为了减轻晶格失配引起的缺陷和硅衬底的氧化,人们早些年在衬底与ZnO之间镀上一层纳米级的Znf31I,最近镀上一层CaF。或Al【32】作缓冲层或对Si衬底进行表面氮化处理【33】,并都有比较明显的效果。应用氢钝化方法提高载流子浓度(如10“cm弓量级)和薄膜的质量、增强带隙紫外发射在国外得到较多的研究【341。近期有人提出避免高温下ZnO/Si界面组分的互扩散和Zn2Si04、Q—Si的产生口”,以提高Si衬底上的ZnO薄膜的质量。
1.4.2P型ZnO薄膜研究
本征ZnO呈n型,其中的主要缺陷是氧空位、锌空位和间隙锌。早期人们对于P型ZnO的掺杂认识上比较模糊,如认为I族元素掺入锌空位或V族元素掺入氧空位,都可以形成受主,从而制备出P型ZnO。但在用IA族的Li掺杂失败136】和取得了~些其他的实验经验之后,人们开始认识到氧空位的重要性,因此V族元素的掺杂成为制备P型ZnO薄膜的首选。2000年左右,Yamamoto和Yoshia[37,381从理论上研究了P掺杂和n掺杂的单极性现象。认为单极性现象表明了掺杂元素的活性,这种活性可由“Madelung能”来描述:Madelung能为正,表示P掺杂,为负则为n掺杂;Madelung能的绝对值越大,表明单极性越强或掺杂元素的活性越差。根据上述的理论和实验经验,P型掺杂的基本方法有三种:(1)将V族元素掺入氧空位【39J;(2)I族元素和Ⅶ族元素(实验上尚未有报道),或III族元素和V族元素共掺入ZnO[401;(3)用过量的氧消除氧空位的自补偿效应【411,这种方法常与V族元素的掺杂同时进行。(详见4.2节)另外,最近还有其他方法,如应用Zn。N。的氧化制备P型掺氮ZnO等【42】。
参考文献
1.SutichaiChaisitsak+,TakeshiSugiyama,AkiraYamadaIandMakotoKonagail.Cu(1nGa)Se2Thin-film
DepositedbyAtomicSolarCellswithHighResistivityZnOBufferLayersLayerDeposition.JpnJApplPhys,1999,Voll38:4989.4992.
2.刘彦松,王连卫,黄继颇等.利用ZnO缓冲层制备A]N薄膜.压电与声光,2000,22(5):332—325.
3.SukkarMH.TIlllerHL.AdvancesinCeramics.Columbus:AmericanCeramicSociety,1982.V01.7.71-72.
4.MahanGD.IntrinsicdefectsinZnOvaristors.JApplPhys,1983,54:3825—3832.
JW‘LauderI.DiffusionofOxygeninSingleCrystalZincOxide.Trans5.Hoffman
FaradySoc,1970,66:2346—2353.
6.ZieglerE,Heinrich
inA,OppemlamlZnOsingleH,eta1.ElectricalStatuspropertiesandnon?stoichiometrycrystal.PhysSolidiA,1981,
66(2):635—641.
7.CohanAF’CederGMorgenD,eta1.First—principlesstudyofnativepointdefectsinZnO.PhysRevB,2000,61(22):15019?15027.
8.VanheusdenK,SeagerCH,WarrenWL,eta1.CorrelationbetweenphotoluminescenceandoxygenvacanciesinZnOphosphors.ApplPhysLett,1996,68(3):403—43-05.
nativeshallowdonor9.LookDC,HemskyJW,SizeloveJR,eta1.Residual
inZn0.PhysRevLett,1999,82(12):2552-2555.
resonance10.KasaiPH.ElectronspinstudiesofdonorsandacceptorsinZnO.Phys
Rev,1963,130:989—995.
11.LookDC.ReynoldsDC、SizeloveJR.eta1.ElectricalpropertiesofbulkZnO.SolidStateCommun,l998,l
12.ReynoldsDC,LookD05(6):399-403.C,JogaiB,eta1.Neutral—donor-bound-excitoncomplexesinZnOcrystal.PhysRevB,1998,57:12151.12155.
13.NagaseT,OoieT,SakakibaraJ.AnovelapproachtOpreparezincoxidefilms:0
excimerlaserirradiationofsolgelderivedprecursorfilms.ThinSolidFilms,1999,357:151-158.
14.JosephBenny,eta1.Astudyonthechemicalspraydepositionofzincoxidethin
filmsandtheirstructuralandelectricalproperties.MaterialsChemistryandPhysics,1999,58(1):71—77.
15.SchulerT,AegerterMA,eta1.Optical,ElectricalandStruc-turalPropertiesof
Sol—GgelZnO:AlCoatings.ThinSolidFilms,1999,351:125—131.
16.BaeSangHyuck,LeeSangYeo,JunJinBeom,ImSeongil.Pulsedlaser
oflightemissionAppliedSurfacedepositionofZnOthinfilmsforapplications
Science,2000,154—155:458—461.
17.SilvaRodrigoFerreira,DarbelloZaniquelli,MariaElisabete.Aluminiumdoped
zincoxidefilms:formationprocessandopticalproperties.JournalofNon-Crystallinesolides,l999,247:248-253.
18.ZayerNK,GreefR,RogersK,etal,Insitumonitoringofsputteredzincoxide
filmsforpiezoelectrictransducers,ThinSolidFilms,1999,352:179-184.
19.ZhangDH,BrodieDE.PhotoresponseofpolycrystallineZnOfilmsdeposited
byLfbiassputtering.ThinSolidFilms,l995,261:334—339.
20.DMBagnall,YFChen,ZZhu,T
excitonicYao,MYShen,andTGoto,Hightemperatureepitaxiallayers,ApplPhysLett,stimulatedemissionfromZnO
1998,73(8):1038—1040.
21.LookDC,ReynoldsDC,HemskyJ
irradiationdamageinZnO.ApplPhys
22。JohnsonMA
ZnOonWProductionandannealingofelectronLett,1999,75(6):881—813.H,eta1.MBEgrowthL,FujitaS,RowlandWandpropertiesofsapphireandSiCsubstmtes.JElectronMater,1996.25(5):885—862.
23.毛祥军,杨志坚,叶志镇等.用MOCVD在ZnO/A1203衬底上生长GaN及其特
性.半导体学报,1999,20(8):639—642.
24.李剑光,叶志镇,汪雷等.用于制备OaN的硅基Zn0过渡层的高温热处理研
究.半导体学报,1999,20(10):862—866.
25.DetchprohmT’Amano
sapphiresubstrateH,HiramatsuusingZnOK,eta1.Growthlayer.JofthickGaNfilmCrystonbybuffer
11Growth,1993,
128rl一4):384-390.
26.Jimnez—GonzlezAE,SotoUmetaJoseA,Surez—ParraR.Opticalandelectrical
characteristicsofaluminum-dopedZnOthinfihnspreparedbysolgeltechnique.JCrystGrowth,1998,192(3/4):430—438.
27.林碧霞,傅竹西,贾云波,廖桂红.非掺杂Zn0薄膜中紫外与绿光发光中
心.物理学报,2001,50(11):2208—2211.
28.汪雷.直流磁控溅射Zn0薄膜的结构和室温PL谱研究.材料科学与工程,
2001,20(3):425—427.
29.张源涛,李万程,王金忠等.射频磁控溅射Zn0薄膜的结构和光学特性.发
光学报,200l,24(1):73—75.
30.邵乐喜,张昆辉,黄惠良.铝掺杂氧化锌薄膜在玻璃衬底上的RF反应共溅
射低温组织生长.半导体学报,2003,24(6):606—610.
31.ZhuxiFu,BixiaLin,GuihongLiaoeta1.TheeffectofZnbufferlayer
andluminescenceofZnOfilmsdepositedonongrowthSisubstrates.JCrystalGrowth,1998.193(3):316-321.
32.李蓓,叶志镇,黄靖云等.以铝作过渡层的C轴取向si基ZnO晶体薄膜的
生长及其肖特基二极管的研制.半导体学报,2004,25(1):64—68.
33.王晓华,范希武,李丙生等.si衬底的氮化处理对Zn0薄膜质量的影响.光
电子?激光,2003,14(8):783—786.
34.RajeshDasandSwatiRay.Zincoxide—atransparent,conductingIR-reflector
preparedrf-magnetronspuRefing.JPhysD:ApplPhys,2003,36:152—155.
35.XiaoliangXu,PeiWang,ZeminQieta1.FormmionmechanismofZn2Si04
crystalandamorphousSi02inZnO/Sisystem.JPhys:CondensMatter,2003,15:L607一L613.
36.HachigoA,NakahataH,HigakiKeta1.HeteroepitaxialgrowthofZnOfilmson
diamond(111)plane
65(20):2556-2558.bymagnetronsputtering.ApplPhysLett,1994,
37.YamamotoT'Karaymna—YoshiaH.p-rypeElectricalConductioninZnOThin
FilmsbyGaandNCodoping,JpnJApplPhys,1999,38:L1205—1210.
a38.YamamotoT.Karayama—YoshiaH.UnipolarityofZnOwith
12wide—bandgapand
itssolutionusingcodopingmethod.JCrystGrowth,2000,214/215:552—55539.Kazunori
ZincMinegishi,YasushiKoiwai,YukinobuKikuchieta1.Growthofp-typeOxideFilmsbyChemicalVaporDeposition.JpnJApplPhys,1997,36:L1453.1455.
40.AVSingh,RMMehra,AWakaharaeta1.P—typeconductionincodopedZnO
thinfilms.JApplPhyS,2003,396—399.
41.GuangXiong,JohnWikinson,BrianMischuck,eta1.Controlofp-andn-type
conductivityinsputterdepositionofundopedZnO.ApplPhysLett.2002,80(7):1195—1197.
42.EKaminska,APiotrowska,JKossuteta1.P-typeconductingZnO:Fabrication
andcharacterisation,PhysStatSol,2005,2(3):1119-1124.13
第2章薄膜生长理论及制备技术、溅射基本原理与设备2.1薄膜生长理论
薄膜通常由材料的气态原子凝聚而形成的。在薄膜形成的最早阶段,原子凝聚是以三维成核的形成开始的,然后通过扩散过程核长大形成连续膜…。薄膜形成的方式确实是独特的。薄膜新奇的结构特点和性质大部分归因于生长过程,因此薄膜生长对薄膜技术而言是最为基本、最为重要的。
2.1.1形核过程(凝聚过程)
气态原子的凝聚是气态原子与所到达基片表面通过一定的相互作用实现的,这一相互作用即为气态碰撞原子被表面原子的偶极矩或阴极矩吸引到表面,结果原子在很短时间内失去垂直于表面原予的速度分量。只要原子的入射能量不太高,则气态原子就会被物理吸附,被吸附的原子称为吸附原子。吸附原子可以处于完全的热平衡状态,也可以处于非热平衡状态。由于来自表面和本身动能的热激活,吸附原子可以和其他吸附原子作用形成稳定的原予团或被表面化学吸附,同时释放凝聚潜热。如果吸附原子没有被吸附,它将会重新被蒸发或被脱附到气相中。因此,凝聚是吸附和脱附过程的平衡净效果。
碰击原子被注入到基片(表面)的几率称为“凝聚”或“黏滞”系数。它由凝聚在表面上的原子数与总碰击原子数之比来确定。许多研究人员研究了捕获入射原子以及入射原子通过范氏力进行能量交换等问题。通过采用原子和一雉点阵弹簧进行正碰撞模型,人们得到:对于碰击原子和基片原子具有几乎相同质量的情况下,可以得到凝聚系数为1,而碰撞原子的动能比脱附能QdcS大25倍。而对于三维点阵,对入射撞击原子的捕获是不完全的,原则上是由于三维点阵的较大僵硬性所致。如果碰撞原子比基片原子轻得多,或者入射原子具
有很高的动能,则黏附系数远远小于1。
2.1.2生长过程
具有明显特征的顺序沉积阶段如下:(1)首先形成无序分布的三维核,然后少量的沉积物迅速达到饱和密度,这些核随后形成所观察到的岛,岛的形状由界面能和沉积条件决定。整个生长过程受扩散控制,即吸附和亚临界原子团在基片表面扩散并被稳定岛俘获。(2)当岛通过进一步沉积而增大尺寸时,岛彼此靠近,大岛似乎以合并小岛而生长。岛密度以沉积条件决定的速率单调减小。这一阶段(这里暂且表示为合并阶段I)涉及岛间通过扩散实现可观的质量传递。尽管还没有被完全证实,但小岛在高温下,在表面的物理移动是非常可能的。小岛的消失一般非常迅速(小于几分之一秒),如果一个半径为lnm的小岛(约103个原子),在0.1S内,在接触面积约为101%m2的面积上,合并到大岛,则质量以约10-18Kg/cm3S传递。(3)当岛分布达到临界状态时,岛的尺寸迅速合并导致形成联通网络结构,岛将变平以增加表面覆盖度。这个过程(合并阶段II)开始时很迅速,一旦形成网络变很快慢下来。网络包含大量的空隧道,在外延生长情况下,这些隧道是结晶学形貌中的空洞。这些隧道偶尔很长,具有均匀宽度,均匀分布。在小区域内,它们具有一定曲线形状。(4)生长的最后阶段是需要足够量的沉积物缓慢填充隧道的过程。不管大面积空位在合并形成复合结构的何处形成,都有二次成核发生。这一二次成核随着进一步沉积,一般缓慢生长和合并。当二次核完全由沉积材料围绕,此效应特别显著。
上述生长顺序对由各种技术获得的其他类型气相沉积膜,从定性上讲是共同的。但是每一步的运动学可能变化很大,这取决于沉积参数和沉积物一基片复合体系。这些差异可以用如团聚和迁移率等术语来描述,形成大岛的增长趋势是增加团聚性,它是吸附原子、亚临界原子团、临界原子团高表面迁移率的结果。但是由于迁移率受到大量的物理参数的影响,无法定量地定义,它可以通过岛密度的变化率或相关物理变量(如膜厚或基片稳定的岛间距离)的测量来实现对它的合理测量。对于在光滑和惰性基片上的低熔点膜,通过增加基片温度、增加沉积率沉积的动能等方法可获得高迁移率。
2.1.3沉积参数的影响
沉积参数对膜生长的影响可以通过沉积参数对吸附原子的黏滞系数、成核密度和表面迁移率的影响来理解。膜的聚集随着表面迁移率的增加而增加,随着成核密度的减小而增加。聚集的增加意味着膜在一较大厚度时达到连续,且膜具有大晶粒和少量被冻结的结构缺陷。
成核密度:在热力学平衡条件下的起始饱和成核密度由基片气相系统确定,与沉积速率无关,但是在沉积率特别高(原子到达基片速率远高于原予的扩散率),气相原子或其表面存在净电荷,表面存在结构缺陷,核能气相原子穿过基片表面缺陷等情况下,上述结论不成立。所有这些因素都引起起始成核密度增加,因此,随后的聚集大为减小。吸附的杂质也影响成核密度。
表面迁移率:随着表而扩散激活能的减小而增加,随迁移过程中吸附原子的有效温度或动能的增加而增加,也随着基片温度和表面光滑度的增加而增加。2.1.4薄膜的生长模式
薄膜的形成过程一般可分为凝结过程、核形成与长大过程、岛形成与生长过程。而薄膜的生长模式可归纳为三种形式:(1)岛状模式(Volmer-Weber模式);(2)单层模式(Frank.VanderMerwe模式):(3)层岛复合模式(Stranski—Krastanov模式)。
岛状生长模式:当最小的稳定核在基片上形成就会出现岛的生长,它在三维尺度生长,最终形成多个岛。当沉积物中的原子或分子彼此间的结合较之与基片的结合强很多时,就会出现这种生长模式。在绝缘体、石墨等基片上沉积余属时,多数显示出这一生长模式。
单层生长模式:最小的稳定核的扩展以压倒所有其他方式出现在二维空间,导致平面片层的形成。这一模式中原予或分子之间的结合要弱于原子或分子与基片的结合。第一个完整的单层会被结合稍松弛一些的第二层所覆盖。只要结合能的减小是连续的,直至接近体材料的结合能值,单层生长模式便可自持。出现这一生长模式的重要的例子是半导体膜的单晶外延生长。
层岛模式:是上述两种模式的中间复合。在形成一层或更多层以后,随后的层状生长变得不利,而岛开始形成。任何干扰层状生长结合能特性的单调减小因素都可能是出现层岛生长模式(从二维生长倒三维生长转变)的原因。例如,由于膜与基片的点阵失配,应变能在生长膜中积累起来,当应变能被释放时,在沉积物与中间层形成界面处的高能量可能激发岛的形成。这一生长模式非常普遍,如在金属基片上沉积金属膜、在半导体基片上沉积金属膜的系统中。2.2制备技术
迄今为止,制备ZnO薄膜的方法主要有:化学气相沉积法口1(ChemicalDeposition)、溶胶一凝胶法‘41(Sol—Gel)、分子束外延法【5】(MolecularVaporBeamEpitaxy)、激光脉冲沉积法旧1(Pulsed
积法[81(Metal.OrganicChemicalVaporLaserDeposition)、金属有机化学气相沉Deposition)、真空蒸发法【9I(Evaporation)、磁控溅射法【10-13](MagnetronSputtering)等。
2.2.1化学气相沉积法
CVD方法是通过把含有构成薄膜元素的一种或几种化合物的单质气体供给基片,利用加热、等离子体、紫外光乃至激光等能源,借助气相作用在基片表面的化学反应(热分解或化学合成)生成要求的薄膜。按工作压强,可分为常压CVD(APCVD)和低压CVD(LPCVD):按激活能源区可分为等离子体CVD(PECVD)、光CVD、热CVD和电子回旋共振CVD(ECRCVD)等:按使用的原料不同,可区分为普通CVD和有机金属CVD(MOCVD)。CVD法的主要控制参数为气体流量、气体成分、沉积温度和沉积基片的几何形状等。
CVD法所需设各相对于溶胶凝胶法而言比较复杂和昂贵,但制备的薄膜相对比较致密、质量稳定可靠。一般CVD法所需要的衬底温度为600℃左右,采用等离子体协助可以适当降低成膜温度。在由辉光放电所形成的等离子体中,由于电子和离子的质量相差悬殊,二者通过碰撞交换能量的过程比较缓慢,所以在等离子体内部没有统一的温度,只有所谓的电子气温度和离子温度。电子
气温度约比普通气体分子的平均温度高10—100倍,电子的能量约为1—10eV,相当于温度104—10’K,而普通气体的温度一般在103K以下。一般情况下等离子体中离子气的温度只有25—300℃左右,所以宏观上来看,等离子体的温度不高,但内部处于受激状态其电子能量足以使气体分子键断裂,并导致具有化学活性的的物质(或分子、离子、原子)的产生,使本来需要在高温下才能进行的化学反应在较低的温度下也能进行,从而在基片上形成固体薄膜。其巾,MOCVD法成膜质量高,并且能实现高速度、大面积、均匀、多片一次生长,符合产业化要求,因此成为人们研究的重点。MOCVD的缺点是原料化学性质不稳定、有毒且价格昂贵,尾气需要专1"3设各处理。
2.2.2溶胶一凝胶法
溶胶一凝胶法是二十世纪六十年代发展起来的一种材料制备方法。自1971年Didlich首次通过溶胶一凝胶法制备出多元氧化物固体材料以后,溶胶一凝胶法就越来越收到人竹]的瞩目。
与传统的物理方法或各种CVD方法相比,用溶胶一凝胶法制备ZnO薄膜不仅设备简单(不需要任何真空条件)和成本低廉,而且还具有以下优点:(1)(TCO)膜的成分比较均匀;(2)用挥发性较强的溶液可以降低成膜温度,从而避免杂质相的生成;(3)可以方便地掺入示踪元素:(4)可以通过调节较多的工艺条件控制薄膜地厚度,如调节溶液的粘滞系数,选择不同的溶剂或选择不同的有机金属盐:(5)可以在任何形状的基体上大面积地成膜,并且可以两面同时成膜。因此(TCO)产业化生产,将会大大降低生产成本。
但是溶胶一凝胶法制备TCO必须经过后续地退火处理(温度超过200。C),这么高的温度只能适用于玻璃衬底,无法满足有机柔性衬底的要求。另外,溶胶一凝胶法制备ZnO薄膜的缺点还有:薄膜厚度的均匀性不易控制,获得的薄膜的质量不高,电阻率相对来说较大。
2.2.3分子束外延
分子束外延技术是七十年代国际上迅速发展起来的一项技术,分子束外延是在超高真空条件下精确控制原材料的中性分子束强度,并使其在加热的基片上进行外延生长的一种技术。从本质上讲,分子束外延也属于真空蒸发方法,但与传统的蒸发方法不同的是,分子束外延系统具有超高的真空,并配有原位监测和分析系统,能获得高质量的单晶薄膜。
由于分子束外延系统具有许多与传统真空蒸发系统不同的地方,因此分予束外延生长有许多自己的独特之处。(1)由于系统是高真空,因此杂质气体(如残余气体)不易进入薄膜,薄膜的纯度高;(2)外延生长一般可在低温下进行,因而可以减少异质结界面的互扩散,实现突变结;(3)可严格控制薄膜成分以及掺杂浓度;(4)对薄膜进行原位检测分析,从而可以严格控制薄膜的生长及性质。但是,分子束外延生长方法也存在着一些问题,如设备昂贵、维护费用高、生长时间过长、产率低、不易大规模生产等。
MBE生长中的掺杂技术:用MBE制作半导体器件,必须解决掺杂问题,即要精确地控制外延层中旖主和受主的浓度和它们的分布。由于MBE法生长比其它生长技术衬底温度低很多,有利于降低化学比缺陷,抑制外延层与衬底之间的交叉扩散,克服内在缺陷产生的自补偿效应,尤其适用于II一Ⅵ族单极性材料的掺杂。
近年来人们又发展了激光分子束外延(L-MBE)114】利用激光熔蒸靶材原子进行靶材原子的物理沉积,这种方法除具有传统分子束外延的优点以外,还可有效的保持靶材组分的稳定性。但传统分子束外延的一些主要缺点仍没有克服,如:设备昂贵、维护费用高、生长时间过长、不易大规模生产等。
2.2.4金属有机化学气相沉积法
金属有机化学气相沉积是二十世纪六十年代末,七十年代初发展起来的一种新型半导体薄膜生长技术。它以H2为载气,使金属有机化合物和非金属氢化物经由一定的管道控制网络,流过加热的衬底上发生局域反应,从而形成外延
层。在1968年Rockwell实验室的HaroldManasevit等人把这项技术推广到许多其它化合物的生长。如AlAs、InAs、GaP、lnP等,并用来制造发光器件和其它有用的器件。
MOCVD技术克服了MBE成本高、产量低、不利于规模生产等弱点,可在同一装置中以任何顺序生长多种III-V族合金材料或II一Ⅵ族材料,外延面积大,产量高,表面形貌和光电特性好,特别适合于异质结构和超晶格量子阱等超薄层微结构材料的生长。在MOCVD法生长ZnO的过程中Zn的Mo源的合理选择是影响薄膜特质的核心问题。长期以来人们多选用DEZ(diethylzinc,二乙基锌),它比DMZ(dimethylzinc,二甲基锌)的蒸气压低,用于生长ZnO其生长速率会降低,但可保证薄膜厚度及晶粒尺寸的均匀性,从而提高了薄膜的质量。也有人选用Zn(COOH)2(醋酸锌)代替DEZ和DMZ作为Zn源,为防止DEZ和DMZ与氖气过早反应而造成的ZnO膜的不均匀性。关于02源的选择也存在一些争议。有人认为采用H20作为02源得到了单一取向的ZnO薄膜,认为采用N20或02将得到非晶。而有人{llIJ认为,DEZ加02或H20都存在预先反应问题而难于控制ZnO的沉积.而采用C02或N20代替02及H20则反应速率太低。他们主张采用醇类作02源,认为尤其是特丁醇效果最好。而采用02源目前己得到最佳的结果。总之,zn及02源的选择还有待进一步的研究。
2.2.5真空蒸发法
真空蒸发法是指在真空室中,加热蒸发容器中待形成薄膜的原材料,使其原子或分子从表面气化逸出,形成蒸气流入射至衬底表而凝结形成固态薄膜的方法。按蒸发源加热部件的不同,蒸发镀膜主要可分为:电阻蒸发、电予束蒸发、高频感应蒸发。此外还有其他特殊的蒸发方式如电弧蒸发法、激光蒸发法等。
真空蒸发法一般具有如下优点:所有设备简单。操作容易,制成的膜纯度高、质量好,膜厚可以比较准确的控制,成膜速率较快,效率高,膜的生长机制比较单一。但是,这种方法的主要缺点就是有机衬底温度比较低时,不易获
得具有良好结晶结构的薄膜,形成的薄膜在柔性衬底的附着力小,工艺重复性不好。
2.2.6磁控溅射法
溅射法是在高真空中,充以惰性气体(m)在高频高压电场的作用下,使气体电离,在阳极和阴极间产生辉光放电,形成高能的离子流,轰击在阴极(又称靶电极)上,使靶电极材料沉积在衬底基片上,形成所需要薄膜。当使用射频电源时,称为“射频溅射”,当使用直流高压电源时,称为“直流溅射”。直流和射频的反应式、非反应式溅射,以及最近几年发展起来的磁控溅射和离子束溅射都被广泛应用。重要的控制参数是:靶的成分、各气体分压、溅射功率、衬底偏压、靶和衬底相对位置和衬底温度。通过优化参数,可制备出所需的薄膜。
与其他方法相比溅射法有以下优点:(1)可以通过调节制备工艺参数,如靶材中的成分配比、沉积速率、溅射功率、衬底温度、衬底偏压、溅射时间等,优化薄膜的性能。(2)薄膜与有机衬底之间的附着性好。由于溅射原子的能量比蒸发原子的能量高l一2个数量级,因此高能粒子沉积在衬底上进行能量交换,产生较高的热能,增强了溅射原子与衬底的附着力。而且一部分高能量的溅射原子将产生不同程度的注入现象,在衬底上形成一层溅射原子与衬底材料原子相互混溶的伪扩散层。此外高能的溅射原子可以将其能量传递给已沉积的原子,有助于已沉积的原子或原子团迁移,结晶。(3)溅射镀膜法获得的薄膜密度高,针孔少,而且薄膜的纯度较高。(4)膜厚可控和重复性好。由于溅射镀膜时放电电流和靶电流可分别控制,通过控制靶电流则可有效控制溅射功率,所有溅射镀膜的膜厚可控性和多次溅射的膜厚再现性好,能够有效地镀制预定厚度地薄膜。此外,溅射镀膜还可以在较大面积上获得均匀地薄膜。溅射镀膜地缺点是:溅射设备复杂,溅射过程中有温度升高,对柔性衬底表面有损伤,比真空镀膜成膜速率低,衬底温度升高和易受杂质气体地影响。但通过采用射频溅射和磁控溅射可以有效地克服沉积速率低和衬底温度升高的缺点。综上所述,制备ZnO薄膜的方法很多,各有其优缺点。而磁控溅射法由于
具有沉积速率高、成膜均匀、致密、且制备工艺简单、成本低、且可与硅微电子平面工艺相容等优点,易于推广,具有广阔的应用前景。
2.3溅射法的基本原理及其特点
如果固体或液体受到适当的高能粒子(通常为离子)的轰击,则固体或液体中的原予通过碰撞有可能获得足够的能量从表面逃逸,这一将原子从表面发射出去的方式称为溅射。1852年,Grove在研究辉光放电时首次发现了这一现象。与蒸发镀膜相比,溅射镀膜发展较晚,但在近代,特别是现在,这一镀膜技术却得到了广泛的应用。
2.3.1溅射的基本原理
溅射是指具有足够高能量的粒子轰击固体(称为靶)表面使其中的原子发射出来。早期人们认为这一现象源于靶材的局部加热。但是,不久人们发现溅射与蒸发有本质的区别,并逐渐认识到溅射是轰击粒子与靶材粒子之问动量传递的结果。
溅射过程实际上是入射粒子(通常为离子)通过与靶材碰撞,进行~系列能量交换的过程,而入射粒子能量的95%用于激励靶中的晶格振动,只有5%左右的能量是传递给溅射原子的。以最简单的直流辉光放电等离子体构成的离子源为例,入射离子产生的过程如下:考虑一个简单的二级系统。在两极加上电压,系统中的气体因为宇宙射线辐射会产生一些游离离子和电子,但是其数量是很有限的,因此所形成的电流是非常弱的,这一区域称为无光放电区。随着两极间电压的升高,带电离子和电予获得足够高的能量,与系统中的中性气体分子发生碰撞并产生电离,进而使电流持续地增加,此时由于电路中的电源有高输出阻抗限制之势致使电压呈一匣定值,这一区域称为汤森放电区。此区域,电流可在电压不变的情况下增大。当电流增大到~定值时,会发生“雪崩”
现象。离子开始轰击阴极,产生二次电子,二次电子与中性气体分子发生碰撞,产生更多的离子,离子再轰击阴极,阴极又产生更多的二次电子,大量的离子和电子产生后,放电便达到了自持。气体开始起辉,两极间的电流剧增,电压迅速下降,放电呈负阻特性,这一区域叫做过渡区。之后,电流平稳增加,电压维持不变,这一区称为正常辉光放电区。在这一区域,随着电流的增加,轰击阴极的区域逐渐扩大,到达l临界点后,离子轰击已覆盖至整个阴极表面。此时继续增加功率,则使两电极间的电流随着电压的增大而增大,这一区域称为“异常辉光放电区”。在这一区域,电流可以通过电压来控制,从而使这一区域成为溅射所选择的工作区域。在此之后,继续增加电源功率,两极间的电流迅速下降,电流则几乎由外电阻控制,电流越大,电压越小,这一区域称为“弧光放电区”。
众多的电子、原子碰撞导致原子中的轨道电子受激跃迁到高能态,而后又衰变到基态并发射光子,大量的光子便形成辉光。辉光放电时明暗光区的分布情况如图2.1所示,从阴极发射出来的电子能量低,很难与气体发生电离碰撞,这样在阴极附近形成阿斯顿暗区,电子一旦通过阿斯顿暗区,在电场的作用下会获得足够高的能量与气体发生碰撞并使之电离,离化后的离子与电子复合湮灭产生光子形成阴极辉光区。从阴极辉光区出来的电子,不具有足够的能量与气体分子碰撞使之电离,从而出现另一暗区,叫克鲁克斯暗区。克鲁克斯暗区的宽度与电子的平均自由程有关。通过克鲁克斯暗区以后,电子又会获得足够高的能量与气体分子碰撞并使之电离。离化后的离子与电子复合后又产生大量的光子,从而形成了负辉光区。在此区域,正离子因其质量较大,向阴极的运动速度较慢,形成高浓度的正离子,使该区的电位升高,与阴极形成很大的电位差,此电位差称为阴极辉光放电的阴极压降。经过负辉光区后,多数电子已丧失从电场中获得的能量,只有少数电子穿过负辉光区,在负辉光区与阳极之间是法拉第暗区和阳极光柱,其作用是连接负辉光区和阳极。在实际溅射镀膜过程中,基片通常置于负辉光区且作为阳极使用。阴极和基片之间的距离至少应是克鲁克斯暗区宽度的3~4倍。
阳极暗区
阴
极阳极
图2-I辉光放屯时明暗光区示意图
溅射因电极不同可分为直流溅射、射频溅射、磁控溅射等。直流溅射系统只适用于良导体的靶材的溅射:射频溅射适用于绝缘体、导体、半导体等任何一类靶材的溅射;磁控溅射具有沉积温度低、沉积速率高两大特点。还有一种溅射方法,其溅射所获得的薄膜材料于靶材不同,这种方法称为反应溅射法。即在溅射镀膜时,引入的某一放电气体与溅射出来的靶原子发生化学反应而形成新物质。如在02中溅射反应获得氧化物,在N2或NH3溅射反应中获得氮化物等。
(1)射频溅射原理
如果靶材换成绝缘靶,则在离子轰击过程中,正电荷便会积累在绝缘体的前表面。为了防止这种电荷积累现象的出现,Anderson等人【I”设计了沉积绝缘体的溅射系统,随后Davidse和Maisselll61将这种设计研制成一种实用系统。在这一系统中,射频电势加在位于绝缘靶下面的金属电极上。在射频电势的作用下.在交变电场中振荡的电子具有足够高的能量产生离化碰撞,从而使放电达到自持,不再需要阴极产生二次离子的高压。由于电子比离子具有较高的迁移性,相对于负半周期,jF半周期内将有更多的电子到达绝缘靶表面,而靶将变成负的白偏压。在绝缘靶表面负的直流电位将在表面附近排斥电子,从而在靶前产生离子富集区(与克鲁克斯暗区相对应)。这些离子轰击靶,便产生溅射。在平行于射频场的方向上旎加磁场,磁场将限制电子使之不会损失在辉光区,进而可以改善射频放电效率。因此,磁场对于射频溅射是非常重要的。在靠近
金属电极的另-N要放置接地的金属屏蔽物以消除在电极处的辉光,防止溅射金属电极。而且,射频源在金属电极上配备耦合电容器(使金属电极上存在负偏压),也可以射频溅射金属。由于射频溅射可在大面积基片上沉积薄膜,从经济角度考虑,射频溅射是非常有意义的。
(2)磁控溅射原理
自从二十世纪七十年代早期磁控溅射诞生以来,磁控溅射技术在高速率沉积金属、半导体和介电薄膜方面已取得了巨大进步。磁控溅射除可以在较低温度下的到较高的沉积速率以外,也可以在较低的基片温度下获得高质量的薄膜。磁控溅射可以描述成通过交叉的电磁场增加了电子在等离子体中漂移的路程。由于离子和电子迁移率的差别引起正离子区靠近靶阴极,相对于等离子体具有一个负漂移电位。由于在阴极区正离子聚集形成场,离子将从等离子体中分离出来,并被加速直至打到靶上,导致靶材的溅射。溅射率基本由在靶上的电流密度、靶与基片距离、靶材、压强、溅射气体组分等决定。当在磁控溅射系统中将射频电压加在绝缘体上时,离子和电子迁移率的不同将导致阴极负自偏压的形成,由此提供溅射所需的电势。
(3)反应溅射原理
在存在反应气体的情况下,溅射靶材时,靶材料会与反应气体反应形成化合物(如氧化物或氮化物),这就是反应溅射。在惰性气体溅射化合物靶材时由于化学不稳定性往往导致薄膜较靶材少一个或更多组分,此时如果加上反应气体可以补偿所缺少的组分,这也可视为反应溅射。在典型的反应溅射系统中,反应气体与靶发生反应,在靶表面形成化合物,这~现象称为靶中毒。当靶中毒发生时,溅射率急剧下降(相当于溅射化合物)。靶中毒对反应溅射沉积的影响取决于金属和反应气体的结合特性以及所形成化合物表层的性质。2.3.2溅射镀膜的特点
(1)对于任何待镀材料,只要能做成靶材,就可以实现溅射(2)溅射所获得的薄膜与基片结合较好;
(3)溅射所获得的薄膜纯度高,致密性好;
(4)溅射工艺可重复性好,膜厚可控制.同时可以在大面积基片上获得厚度均匀的薄膜。
溅射也存在缺点:相对于真空蒸发,它的沉积速率低,基片会受到等离子体的辐照等作用而产生温升。
2.3.3溅射参数
表征溅射特性的主要参数有:
(1)溅射闽值:指将靶材原子溅射出来所需的入射离子最小能量值,溅射阈值随靶材原子系数的增加而减小。
(2)溅射率:表示入射正离子轰击靶阴极时,平均每个正离子能从靶阴极中打出的原子数。溅射率与入射离子的种类、能量、角度、以及靶材的种类、结构等有关。
(3)溅射原子所具有的能量和速度。
2.4FJL450E型磁控与粒子束复合溅射设备
2.4.1概述
该设备具有磁控与离子束溅射双重功能,可制备金属多层膜,可溅射沉积各种合金、化合物、各种金属膜、半导体膜、高温超导薄膜等,同时还可以进行单离子束溅射、双离子束溅射以及离子束清洗和离子束轰击等,在电子学、物理学、材料科学研究领域具有较大的实用价值。
本设备是根据磁控溅射的原理,在真空中以磁场改变电子运动方向,提高了电子对工作气体的电离儿率和有效的利用了电子的能量,使之在形成高密度等离子体的异常辉光放电中,正离子对靶村轰击所引起的靶材溅射更加有效,从而使溅射出来的粒子在基片上沉积成膜,使其具备了低温、高速两大特点。26
2.4.2主要设备
(1)HTFB型复合分子泵
(2)HTFB单片机中频电源
(3)2XZ系列直联高速旋片式真空泵(4)FZh一2K型复合真空计
(5)D07.7A/ZM型质量流量控制器
(6)D08.2A/ZM型质量流量显示电源盒
(7)BODH—1310型高频功率步进电机驱动器(8)英国欧陆808温度调节器
参考文献
1.郑伟涛编著.薄膜材料与薄膜技术.化学工业出版社,2004年.PP.142.2.T.Shiosaki.S.OhnishiandA.Kawabata.Opticalpropertiesofsingle-crystalline
ZnOfilmsmoothlychemical-vapordeposited
ZnOfilmononintermediatelyspuueredthin7.sapphire.JApplPhys,1979,50(5):3l13-31l
3.EmanetogluNW,LiangS,GorlaC,LuY,JenS,SubramanianR.Epitaxialgrowth
andcharacterizationofhighqualityZnOfilmsforsurfaceacousticwaveapplications.IEEEUltrasonicsSymposium,1997,v01.1:195-200.
4.JiZhenguo,SongYongliang,YangChengxing,eta1.CharacterizationofZnOThin
FilmPreparationbySol-GelSpinning—Coating.ChineseJournalofSemiconductors,2004,25:52—55.
5.DMBagnall,YFChen,ZZhu,eta1.HightemperatureexcitonicstimulatedemissionfromZnOepitaxia[1ayers.ApplPhysLett.1998,73(8):1038—1040.6.A.Suzuki,TMatsushita,YSakamoto.TransparentConductingAI—DopedZnO
ThinFilmsPreparedby
、,01.35:L56—59.
7.NJlanno.LMcConville。eta1.Characterizationofpulsedlaserdepositedzinc
oxide.ThinSolidFilms,1992,220(11):92-99.PulsedLaserDeposition.JpnJ.ApplPhys,1996,
8.WWWenas,AYamada,M
DepositionofZnOUsingKonagai,etD20asa1.MetalorganicJChemicalVaporPhys,1994,Oxidant.JpnAppl
Vjl.33:L283.285.
9.HSankur,JTCheung.HighlyorientedZoOfilmsgrownbylaserevaporation.J
VacSciTechnol,1983,V01.1(4):1806-1809.
10.MakotoKasuandNaokiKobayashi,Field-emissioncharacteristicsandlarge
currentdensityofheavilySi-dopedA1NandAIxGalxN(O.385x<1).ApplPhysLett,2001,79(22)3642-3644.
11.KiHyunYoon,ChoiJi—Won,LeeDong?Heon.CharacteristicsofZnOthinfilms
depositedontoAI/Sisubstratesbyrfmagnetronsputtering.ThinSolidFilms,1997.302:116-121.
12.AHachigo,HNakahal,KHigaki,eta1.HeteroepitaxialgrowthofZnOfilmson
diamond(111)planebymagnetronsputtering.ApplPhysLett,1994,65(20):
2556.2558
13.BWacogne,MDRoe,TJPatcinson,eta1.Effectivepiezoelectricactivityofzinc
oxidefilmsgrownbyradio—frequencyplanamagnetronsputtering.ApplPhysLett.1995,67(12):1674—1676.
14.YMatsumoto.MMurakami.ZhenwuJineta1.CombinatorialLaserMolecular
BeamEpitaxy(MBE)GrowthofMg—Zn一0AlloyforBandGapEngineering.JpnJApplPhys,1999,V01.38:L603?605.
15.GSAnderson.WNMayer,eta1.CalculationofIonBombardingEnergyandIts
DistributioninrfSputtering.JApplPhys,1962,33:2991.
16.PDDavides.LMMaissel.Transactionsofthe3rdInternationalVacuum
Comgress.Stuttgart.JApplPhys,1966,37:574.
第3章制备工艺对ZnO薄膜的结构及光学性质的影响3.1引言
氧化锌是一种新型的宽禁带化合物半导体材料,由于其优异的压电、光电性能…以及高化学稳定性,在许多领域尤其在光电器件领域有着重要的应用。而ZnO在光电器件卜-的应用关键取决于能否生长出ZnO同质p—n结所需要的高结晶质量的P型ZnO薄膜[2,31,根据前期的丁作经验,我们认为,由于在低温情况下,高掺磷的硅基衬底中的磷(P)不易扩散或挥发,而在高温下进行退火处理时,衬底中的磷很容易扩散到ZnO薄膜中,从而能够实现P型ZnO薄膜的制备。凶此,ZnO薄膜的低温生长法对实现在高掺杂磷的硅基上生长P型ZnO薄膜有着现实的意义,而研究低温生长ZnO薄膜的性质与其制备工艺之间的规律,对生长高质量P型ZnO薄膜有着重要的指导意义。
有关ZnO薄膜的制备方法已经有很多报道,常用技术有脉冲激光沉积(PLD)、金属有机物化学汽相沉积(MOcvD)[”、分子束外延(MBE)【51以及磁控溅射16-81等。对于磁控溅射技术,由于其工艺条件容易控制等方面的优势,是一种常用的薄膜制备技术。本文采用低温磁控反应溅射的方法分别在石英玻璃基底及硅基衬底上制备出了ZnO外延薄膜,并通过X射线衍射仪、原子力显微镜、分光光度计等仪器进行测试研究了ZnO薄膜的结构和光学性质。
3.2实验
3.2.1衬底及样品架的清洗本实验所用的衬底和样品架均是采用超声波清洗机清洗的。
(1)石英玻璃基底的清洗
石英玻璃表面往往会受到大量分子或离子的污染,所以在镀膜之前必须经过严格清洗。清洗过程如下:
a)将石英玻璃片放入石英杯中,并向杯中加入一定量的丙酮,超声波清洗槽注入一定量的水,把石英杯放入清洗槽(槽内先注入一定量的水)超声清洗一次(8分钟),去除石英玻璃片上的有机污染物;
b)再向石英杯注入一定量的无水乙醇溶剂,同样放在超声槽中超声清洗一次(8分钟),溶解a)操作中加入的丙酮;
c)用大量去离子水超声清洗三次,每次超声5~10分钟,除去石英片上的K+、Ca2+等金属离子;
d)把石英玻璃片从去离子水中取出,用N2气吹干后,放入洁净的干燥瓶中备用。
(2)硅基底的清洗
由于硅片表面除了粘附大量分子和离子污染物以外,其表面还会在空气中被缓慢氧化形成一层非结晶态的Si02,因此其清洗方法一定的特殊性。其清洗过程如下:
a)把硅片放在石英杯中,加入一定量的丙酮,放进超声清洗槽中,打开超声清洗机电源,超声清洗8分钟;
b)加入适量的无水乙醇溶剂,同样超声清洗8分钟;
c)用大量的去离子水超声清洗三次,每次超声5~10分钟:
e)从去离子水中取出硅片,用N2气吹干后,放入洁净的干燥瓶中备用;f)每次镀膜前,把硅片取出放入塑料容器中,用耐强酸的塑料量筒配制5%的氢氟酸溶液(将氢氟酸倒入去离子水中进行稀释)适量,把配制好的氢氟酸溶液迅速倒入放有硅片的塑料容器中,同时计时,10秒钟后迅速回收氢氟酸溶液。此过程可以腐蚀掉硅片表面被氧化生成的Si02。
(3)样品架的清洗
由于样品架是随同样品一起被拿出真空腔,溅射时又随同样品一起安装在真空腔中,因此它的清洁是不容忽视的,否则将污染真空室及样品。因此在每次使用时,清洗是非常有必要的。其清洗过程同(1)。
3.2.2ZnO薄膜的反应射频磁控溅射法制备
实验是在FJL450E型磁控与粒子束复合溅射设备上进行的,实验选用了纯锌(5N)(北京有研亿金新材料有限公司)靶材。
反应磁控溅射前,反应室抽真空至小于4.0×10‘4Pa,同时衬底升温至4504C恒温15min后再降到溅射所需的温度200。C,充入反应溅射气体,进行溅射。溅射功率为100W,溅射气体总气压保持5Pa,所有样品均溅射120min,不同的02/Ar比(质量比)通过质量流量计来控制。正式溅射前,纯锌靶先预先溅射5min以清除上面的杂质。实验参数及工艺条件列表如下:
表3-1实验参数和工艺条件
靶材
衬底材料
衬底温度
本底真空
工作气压
氧氩比
溅射时问
溅射功率纯锌(5N)石英玻璃、掺P硅片(表面腐蚀和未腐蚀的)200℃2~5×10叫Pa5Pa1:12~8:l120minlOOW
3.2.3ZnO薄膜性质的测试
薄膜的晶体特性及表面结构主要通过由北大青鸟集团生产的BD90X射线衍射(XRD)仪、美国热电公司生产的AmoProbeCPResearch型原子力显微镜(AFM)N【J定;光学性质主要使用了SHIMADUV2501PC分光光度计测试样品的室温吸收光谱,波长扫描范围300nm~600nm,和用日产日立牌F-4500理荧光分光光度计测量样品的室温光致发光PL谱。
3.3形貌、结构与工艺的关系
3.3.1
XRD强度和半高宽
(1)溅射气氛对结构的影响。本节主要讨论对于3.2.2节提到的工艺条件(如表3—1)下,固定除溅射气氛(即表中氧氩比)外的所有溅射参数(如表
3—2),其中衬底选择为石英玻璃基底。在溅射法制备薄膜中,溅射气氛是最主
要的参数之一。尤其对于反应溅射法制各Zn0薄膜,其溅射气氛(这里主要是指通入真空溅射腔中的O:、Ar气的分压强)对其成膜的速率、成膜的质量、化学计量配比等均是至关重要的。而Zn0薄膜的这些结晶质量又与它的光学性质
密切相关,因此研究溅射气氛与溅射形成的Zn0薄膜的结构之间的规律是非常
有意义的。
不同生长条件下沉积样品的xRD的测量结果显示,衍射峰的半高宽和强度
对氧氩比均有明显的选择性依赖关系(如表3.2)。在实验中,如图3.1所示,随02/Ar比从1:12到l:4其衍射峰半高宽由O.303增加到O.456,强度从30265急剧减小到6423;随着02/Ar进一步增加从4:1到6:1其衍射峰半高宽由O.326到0.271,强度从16171增加到26493;当02/Ar再增加时其衍射峰半高宽又增加,而衍射强度也降低。由谢乐公式D=K^/(Bcos0)我们很容易计算出它们的结晶晶粒大小(如表3.2),其中D为小晶粒平均尺寸,K为接近l的常数,^为特征x射线波长(这里为1.54056A),B为衍射线的半高宽(即FWHM)。这些结果均未经过退火处理。
表3-2在石英玻璃基底上,不同溅射气氛下制得Zn0薄膜的XRD实验结果
样品号溅射气氛空气(5pa)
02/Ar=1/1202/Ar=1/402/Ar=4/102/ar=-5/10,/Ar=6/1O,/Ar=7/l02/Ar=8/1
2O(o)
d值(A)
2.64682.62112.63312.62122.62262.624l2.62552.6271
衍射强度
(a.u.)
24023026530591617l17955264932240314764
FWHM
(o)
0.4840.3030.4450.3260.2970.27l0.3000.347
晶粒尺寸
(11111)
1930212831343l27
a
33.83934.18034.02034.18034.16034.14134.12134.100
b
C
d
e
fgh
我们分析认为,造成这种结果的主要原因是,当02/Ar比较小时,Ar气分压大,其溅射成膜速率较大,同样溅射时间下形成的膜比较厚,这时的0。几乎全部与Zn结合并被沉积到衬底上,如图3—1(b),因此有较大的衍射强度和较窄的半高宽。随着O:/Ar比的增加,0:分压增大,Ar气分压减小,使得一部分0:与金属Zn靶材表面反应形成ZnO,大大地减小了成膜速率,因而XRD强度大大地减小,如图3—1(c)所示。又由于这种情况下,靶表面形成的ZnO具有较大的二次电子发射率【91,造成较大的离子密度,因此靶材表面上ZnO层较薄之地方,ZnO被离子轰击掉,这些地方的zn会被优先大量溅射到衬底上,并与剩余的晚结合形成ZnO。由于参与在衬底上成膜的02较少,使ZnO薄膜在较大程度上偏离了Zn/O化学计量配比,品格不完善,因而XRD强度小、线宽也增大,如图3—1(c)所示。随着O:/Ar比的增加,薄膜中的Zn/O化学计量配比和结晶质量得到了一定的改善,其XRD强度变大,峰的半高宽变窄,如图3一l的(d)、(f)所示。当0。/Ar太大时,zn靶材表面将被严重氧化,衬底上的成膜速率将大大降低,使得膜厚减小,因而衍射强度也随之减小,如图3一l(h)所示。由此可见,样品的结晶质量及成膜厚度等与O:/At比有较明显的选择性依赖关系。
202530354045505560
20f(。)
阁3一l在石英玻璃基底上,不同溅射气氛下制得ZnO薄膜的x射线衍射谱比较
(所有样品均未经退火处理)如图3-2所示,从结晶厚度(与XRD衍射峰强度相对应)及结晶晶粒尺寸
(与XRD衍射峰的衍射峰半高宽及衍射角有关)两方面综合考虑,我们认为实
验中0#Ar为1:12及6:1时所成膜的结晶状况更好(即XRD衍射峰强度最大及衍射峰半高宽最窄)。因此,在实验上我们优化选择02/At为l:12及6:l
时所成的膜讨论其在退火前后的结晶状况。在硅基上,其衍射峰仍对02/At有
相似的依赖关系。在硅基上,其衍射峰仍对02/At有相似的依赖关系。
、暑—,bc
d
蜘mm
ef
g
h
bcdef
g
h
SDedn'舯
图3-2在石英玻璃基底上.不同溅射气氛下制得ZnO薄膜的x射线衍射峰的衍射强度及
半高宽(a:衍射强度,b:半高宽)
(2)退火处理对结构的影响。由表3—3可以看出,经高温退火后的样品有以下特点:(1)衍射峰半高宽变窄,衍射峰强度大为增加。这说明经高温退火后的ZnO薄膜晶粒变大,结晶质量更好。(2)衍射峰位置发生了明显变化。退火前2e小于标准ZnO(002)峰的位置34.45,而退火后2e却大于34.45,这种相对于标准值的偏离,与晶体内的内应力有关。退火前小于标准值,说明衍射峰向小角度移动.晶格常数变大,膜中存在张应力。相反,退火后衍射峰略向
大角度移动,说明晶格常数表小,膜中存在压应力。在上表中我们可以看出在
02/Ar为6:l并退火后,其20的值最接近标准值,说明此时膜中的内应力较小。内应力的产生不仅仅与衬底和ZnO薄膜的晶格失配有关,还与生长ZnO的工
艺条件(02/Ar不同、退火与否等)有关㈣。
表3-3在表面未被氢氟酸腐蚀的硅基上生长的ZnO薄膜的XRD实验结果
02/Ar1:1:6:6:
1212l1
退火与否
否
2034.04l34.50034.06034.459
半高宽
0.2720.2480.3390.267
强度
42961280625498287
晶粒尺寸
34372735
450℃退火
否
450℃退火
3.3.1表面形貌
(1)表面形貌与衬底类型的关系。图3.3为不同衬底上沉积的ZnO薄膜的原子力显微图(上方的图为三维图,下方为相应的二维图,以下同)。
(a)(b)(c)
图3—3在不同的衬底上溅射沉积的Zn0薄膜的原子力显微图
(a:表面未被腐蚀的硅基;b:表面被腐蚀的硅基;C:石英玻璃基底:所有样品均未退火
处理,02/Ar均为1:12)
图3—3中a、b、c分别为在表面未被腐蚀过的硅基、被腐蚀过的硅基、石英玻璃基底上溅射沉积的ZnO薄膜,其表面形貌有很大的不同。如,在未腐蚀过的硅基上可形成高达400纳米的ZnO准六角柱(图3.3a),被氢氟酸腐蚀过的硅基上则可形成几十纳米高的ZnO准六角柱(剀3-3b)。这是由于未被氢氟酸腐蚀过的表面比腐蚀过的表而光滑,其成核能自由移动,有利于成核的合并生长,因而比后者更易形成较大的准六角柱。而在玻璃基底上,则没有准六角结构形貌的形成(如图3—3c),这是由于石英玻璃基底是非晶态所致,所以只能形成无规则的岛。由于未腐蚀过的硅基表面仅有几纳米厚的非晶态SiOz,晶格的影响仍能传递上来形成ZnO准六角形貌。上述实验事实说明,在低的衬底温度下,虽然ZnO薄膜的表面不够平整,但仍可以形成较大尺寸的晶团。
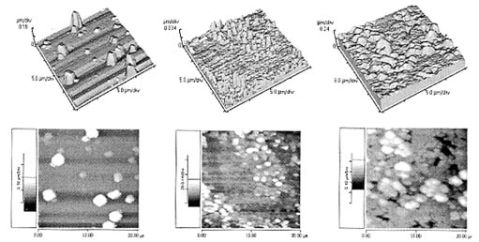
(2)溅射气氛对表而形貌的影响。图3.3中a与图3.4a分别为退火前在不
同的02/At溅射气氛下ZnO薄膜的表面形貌。在不同氧氩比下溅射形成的ZnO岛大小差不多,约为2--3微米;但在岛的形状方面,较小氧氩比(1:12)时形成的岛有明显的准六角结构(图3—3a和图3-4a),而较大氧氩比时却不明显(如图3-4a)。这说明低的氧氩比更有利于ZnO微晶的生长。而退火后随氧氩比的不同,更能明显看出氧氩比为1:12时形成的ZnO薄膜表面颗粒大约为100纳米的量级大于在6:1时形成的颗粒(图3.4b、3-4c)。这与x射线衍射测量结果是一致的(如表3.3)。
图3—4不同溅射气氛下沉积的Zn0薄膜的原子力显微图
(a:()2/Ar为6:1,样品未退火;b:02/At为l:12,经450。C退火;c:02/At为6:l
经45012退火:所有样品均在表面未被腐蚀的硅基上溅射沉积的)
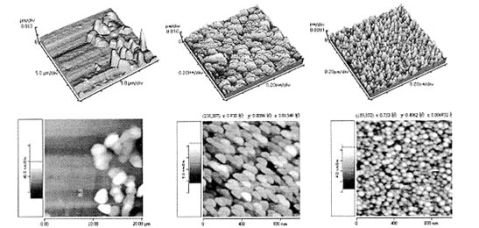

(b)
图3-5退火前后的ZnO薄膜的原子力显微图,a:末退火,b:经4506C退火
(所有样品均在表面未被腐蚀的硅基上溅射沉积的,02/Ar均为1/12)
(3)退火处理对表面形貌的影响。图3.5a和3.5b分别为退火前后的表面形貌。退火前其表面颗粒大小可达2微米(图3-5a),而退火后却只有0.1微米左右(图3-5b)。退火后样品的x射线衍射峰的半高宽变窄说明,退火处理的ZnO的结晶质量更高,晶粒更大。这说明退火前形成的准六角ZnO晶团虽大,但ZnO晶粒并不是很大(如表3.3)。样品经退火处理后,ZnO薄膜表面大为平整。3.4吸收谱、PL谱与工艺的关系
3.4.1吸收光谱
在石英破璃基底上溅射的Zn0薄膜,其室温吸收光谱(图3-6)的光学吸收边都相当陡,都位于370nm附近,相应的室温带隙宽度约为3.35eV,说明薄膜中的纳米晶粒尺寸比较均匀。从图中可以看出,不同条件下制备的样品的吸收光谱性质有一定的差异:
(】)溅射气氛对吸收谱的影响。当02比较少时,吸收谱基本上没有激子峰出现;而当02/Ax增大时,激子峰开始出现。这是因为,在较小02/Ar比时沉积的薄膜中存在着较多的氧空位,而真空退火并不能为ZnO薄膜增加氧组分,氧缺位依然存在。
(2)退火对吸收谱的影响。由图3-6所示,3.6a为经450。C退火后的吸收谱,3.6b为未经退火处理的吸收谱,其02/Ar比均为4:1。可以看出,退火后激子峰增强,且峰位红移。这说明经过高温退火后,ZnO薄膜的晶粒变大。激子峰的增强与其x射线衍射结果是一致的,即结晶质量好、晶格完善的ZnO薄膜(表现在XRD图的半高宽小、强度大,如图3.7)其激子峰强度较大。由此可见,我们可以通过退火工艺来提高ZnO吸收谱激子峰的强度。
九,nm九/nm
图3-6退火前后,ZnO薄膜吸收光谱
(a为经450"C退火,b为未退火)
30000
25000
20000.
15000矗
10000
5000
03
203040506070
20/(。)
图3—7在石英玻璃基底上.不同溅射气氛下制得经450。C退火处理的ZnO薄膜的x射线衍射谱比较
3.4.2光致荧光光谱(PL)
图3-8是退火后Zn0薄膜的室温荧光光谱(PL)。激发光源为xe灯,激发波长为300nm。其中a、b分别是02/Ar比为1:4、4:1叫在石英玻璃基底上沉积的ZnO薄膜的PL谱,C是02/Ar比为4:l时在硅基底上沉积的ZnO薄膜的PL谱。
图3-8退火后的Zno薄膜的光致发光谱
由图可见,不同溅射气氛下生长的ZnO薄膜其荧光光谱有所不同,其中谱线b的发光强度较大而谱线a的发光强度较弱。这是由于样品b的结品质量较好(如图3-7b),而样品a的衍射强度太小,其结品质量较差(如图3-7a)。我们分析认为,结晶质量越好、晶格越完善,其带隙吸收越好(如图3.6),受到激发后有更多的电子被激发到导带底,导带底的电子跃迁到位于导带以下O.27eV的氧空位(Vo)的浅施主能级的几率就越大。这时在Vo能级上聚集了很多电子,因此电子向价带顶的跃迁几率变大,其402nm(3.08eV)的紫光发射就越好…I。
样品c是在硅基上生氏的ZnO薄膜,由于其X射线衍射图的衍射峰强度只有6017,远小于样品b的。因此其室温下没有光致荧光现象。

综上,我们可以得出,样品的结晶质量(x射线衍射图)、PL谱与吸收谱
具有明显的协同关系。
3.5结论
使用RF磁控反应溅射技术,在不同氧氩(02:Ac)比气氛下,分别在SiO:、Si(100)衬底上制备了ZnO薄膜。通过XRD,AFM对所制各的ZnO薄膜结构和形貌进行了表征,发现在硅基上以氧氩比6:l,衬底温度200。C等工艺条件下制备的ZnO薄膜其XRD半高宽最窄,并且形成了高达几百纳米的准六角柱形貌,经过450℃退火后这种结构消失,形成较为平整的ZnO薄膜。这些结果表明,ZnO薄膜的结晶质量及结晶厚度等与0。/Ar比有明显的依赖关系。由ZnO薄膜的吸收谱可以看出:当0。比较少时,吸收谱基本上没有激子峰出现,而当0。/Ar增大时(4:1),激子峰开始出现。我们可以通过退火处理工艺来提高激子峰的强度,此时在近紫#}、402nm的光致发光也被观察到。本文总结TZnO薄膜性质与其制备工艺之间的关系,为制备各种性能完善的ZnO薄膜提供工艺基础。
参考文献
lBagnallDM,ChenY只ZhuZ,eta1.OptiealpumpedlasingofZnOatroom
temperature.ApplPhysLett,1997,70(17):2230—2232.
2.Kyoung’KookKim,Hyun?SikKim,Dae—KueHwang,eta1.Realizationofp-typeZnOthinfilmsviaphosphorusdopingandthermalactivationofthedopant.ApplPhysLett,2003,83(1):63-65.
3.Jin—HoYang,Hyun—SikKim,Jae—HongLim,eta1.TheEffectofAr/02SputteringGasonthePhosphorus-Dopedp-TypeZnOThinFilms.TheElectrochemicalSociety,2006,l53(3):G242一G244.
4.WWWenas,AYamada,M
DepositionofZnOUsingKonagai,eta1.MetalorganicD20asChemicalVaporOxidant.JpnJApplPhys,l994,V01.33:L283.285.
5.DMBagnall,YFChen.ZZhu,ela1.Hightemperatureexcitonicstimulatedemissionfi'omZnOepitaxiallayersApplPhysLett.1998,73(8):1038-1040.6.ReynoldDC,LookDC,JogniB.Similaritiesinthebandedgeanddeep—centrephotoluminesceneemechanismsofZnOandGaN.SolidStateCommun,1997,101:643—646.
7.BylanderEG.Surfaceeffectsonthelow-energycathodeluminescenceofzinc
oxide.JApplPhys,1978,49:1188一1195.
8.BangKH.HwangDK.MyoungJM.EffectsofZnObufferlayerthicknesson
propertiesofZnOthinfilmsdepositedbyradio-frequencymagnenronsputtering.ApplSurfSci,2003.207:359—364.
9.邵乐喜,张昆辉,黄惠良.铝掺杂氧化锌薄膜在玻璃衬底上的RF反应共溅射
低温织构生长.半导体学报,2003.24(6):60661l
10.王卿璞,张德恒,辞忠营.射频磁控溅射Zn0薄膜的光致发光.半导体学报,
2003,24(2):157—161.
11.FuZhuxi,GuoChangxin,LinBixia,eta1.CathodoluminescenceofZnOfilms.ChinPhysLett,1998,l5(6):457—459.42
第4章P型ZnO薄膜的制备及结果讨论
4.1引言
ZnO是一种直接宽带隙的化合物半导体材料,但在相当长的一段时间里,它在光电领域、特别是在短波长LEDs和LDs的应用研究进展缓慢,其主要原因之一是难于获得生长同质p-n结的P型ZnO材料。目前ZnO器件的主要研究对象是LEDs、透明薄膜晶体管、紫外探测器、光波导、光电器件的透明电极及缓冲层等。LEDs分为异质结和同质结两类。异质结LEDs由于结构的原因可以有较强的发光强度,但对两种异质材料的晶格匹配要求比较高,而晶格能和ZnO较严格匹配的材料是比较有限的。n型ZnO薄膜的制备比较简单,通常掺杂Al、Ga、In等元素即可得到电学特征较理想的n型ZnO薄膜。P型ZnO薄膜的制备则很难成功。日本的研究者于1997年首次报道了他们采用CVD方法制备出p型ZnO薄膜…。T.Aoki等采用激光掺杂法将Zn。P:薄膜中的P热扩散掺杂入ZnO制各出P型ZnO薄膜和p-n结。美国Missouri大学研究者采用激光掺杂法将As热扩散掺杂入ZnO制备出P型ZnO薄膜【“J。日本Osaka大学的M.Joseph等人采用让N20气体流经电子回旋共振器形成N等离子体并和Ga元素共掺杂入ZnO的方法制备出低电阻的P型ZnO薄膜口l;随后该校的Guo等人161以纯金属zn片作靶材,采用相似的方法形成N、0等离子体,靶在脉冲激光作用下溅射在熔融的石英或玻璃衬底上,也得到了P型ZnO薄膜。由于ZnO薄膜中存在较强的自补偿机制,使得很难有效地进行p型掺杂。因此,克服自补偿效应和有效地、可控地掺杂,是生长p型ZnO的关键。本研究首次采用了与硅平面工艺相容的“高掺磷Si衬底--ZnO膜磷扩散法”初步制备了p型ZnO薄膜。43
4.2p型ZnO的掺杂理论及常用掺杂方法
4.2.1p型ZnO的掺杂理论
YamaoLo和Yoshida[7】用abinitial计算方法研究了P型和n型掺杂的ZnO中的“单极性”现象。这种“单极性”现象表明了掺杂元素的活性,可由“Madelung能”描述:Madelung能为正,表示P性掺杂:为负则表示n型掺杂。Madelung能的绝对值愈大,表明单极性愈强或掺杂元素的活性愈差。氮原子的Madelung能较小而Li的很大,这是Li作为P型掺杂不成功的原因之一。但是直接用N:掺杂制备P型ZnO也不成功,原因是N。的离化势较大(15.65eV),不易产生N并掺入ZnO。Minegishi…等用N乩作为掺杂源,使N在一定条件下掺入ZnO而形成p-ZnO。这些N卜b分解后产生大量的氢,有较强的钝化作用,因此成品率较低,且生成的ZnO电阻率较大,不利于应用。鉴于这些原因,Yamamoto和Yoshida建议采用rl型与P型共掺杂法,减少单极效应,增加P型掺杂元素的活性。比如,Li、F共掺杂在ZnO中占据最近邻位置并形成LiF-Li复合体,产生的受(施)主能级位于禁带的底(顶)部,这样的能级位置是合适的。而且Li一卜Li复合体的场被认为是一种短程的偶极子作用对ZnO中载流子的迁移率不会产生很大的影响。
4.2.2常用掺杂方法
根据以上的理论和实验经验,有3套方法可用来制备P型ZnO:(1)将V族元素掺入氧空位;(2)将I族元素与Ⅶ元素共掺入ZnO,或V族元素与III族元素共掺入ZnO;(3)用过量的氧以消除氧空位的自补偿效应,这一类方法常与V族元素掺入法同时进行。
4.2.2.1将V族元素掺八氧空位
目前报道最多的掺杂元素是N,其它元素还有P和As。
N掺杂方面:由于N。的离化势高很高,所以在直接掺入工艺中,人们较多的选用NH3作为掺杂源。1997年,K.Minegishi等人隅墚用以N乩作为掺杂源的CVD技术,首次实现了ZnO薄膜的P型转变。吕建国等采用以叱作为掺杂源的直流反应溅射方法,在蓝宝石衬底上生长出具有高度c轴取向的P型ZnO薄膜。近年来,x.L.Guo等人tgJN用等离子体增强激光脉冲沉积反应技术,制备了p型ZnO薄膜和室温下发射浅蓝一白光的LEDs。
As掺杂方面:Y.R.Ryu等人¨0l应用PLD技术,在GaAs衬底上沉积了ZnO薄膜,经退火As向ZnO层扩散而得到P型ZnO薄膜。
磷掺杂方面:T.Aoki等人…】在n型ZnO单晶片表面蒸发了一层Zn。P。薄膜,然后用KrF紫外脉冲激光照射,Zn。P。分解为Zn、P原子,P原子扩散进入ZnO晶体,取代0原子而形成P型ZnO,并与n型衬底间形成同质p-n结。Kyoung—KookKim等人利用射频磁控溅射法,用含有1wt%o的P20。的陶瓷ZnO作溅射源,以未掺杂的ZnO薄膜为缓冲层制备了n型ZnO薄膜后在高于800℃条件下退火得到p型ZnO薄膜。最近,Jin-HoYang等人【比1再用射频磁控溅射法,制各了掺磷的p型ZnO薄膜。实验表明,氧氩比对这种薄膜的结构有重要的影响。
4.2.2.2V族元素与Ⅲ族元素共掺杂
这种方法,目前只有N掺杂方面的报道。M.Joeeph[131、A.V.Singh[141及J.M.Bian[15l等人制备了Ga+N、In+N共掺杂的P型ZnO薄膜。J.M.Bian[‘51等人应用超声喷雾热分解法制备的In+N共掺杂的P型ZnO薄膜,并在此基础上制各了ZnO同质p—n结116j,但没有发光的报道。浙江大学分别以N儿和N:0作为氮源UTjs],利用直流反应溅射技术进行Al、N共掺杂制备了p型ZnO薄膜。但由于氢钝化的影响,使得薄膜的载流子浓度较低。6uangXiong、JohnWilkinson等人【191认为,由于磁控溅射在分解N。使之成为N原子并掺入ZnO中的特殊有效作用,所以应用磁控溅射法制备掺N的P型ZnO薄膜,N。也是一种有效的氮源。45
4.2.2.3用过量的氧以消除氧空位的自补偿效应
GuangXiong、JohnWiikinson等人【19l于2002年报道了通过控制直流反应磁控溅射等离子体中氧氩比例.就可获得p型Zn0薄膜。当0。比例大于55%是得到P型Zn0薄膜,电阻率为3Q?cm。中国科技大学的许小亮等‘201于2004年报道了他们用类似的方法制备了P型gnO薄膜,溅射气体氧氲比为(5一lO):(1—3)。
综上所述,在V族元素中,N在理论上被认为是最理想的受主杂质,而且人们在N掺杂制备P型Zn0薄膜及其同质p-n结方面所做的研究工作最多,直到2005年,除了应用MOCVD方法制各的P型Zn0薄膜及其同质p-n结电致紫外光发射的有关报道以外,还未见其它制备方法制备的ZnO同质p-n结有较强的带隙电致发光的报道。至于磷元素,尽管从理论上讲,作为受主杂质,它没有N元素优秀,磷掺杂制备P型ZnO薄膜的研究至今还很少,但也于2005年有了研制成功并有较强带隙电致发光的报道,其制备方法是与硅平面工艺相容的、适合大规模生产、经济实用的射频磁控溅射法。
4.3P型ZnO薄膜的制各
在这组实验中,为了得到较好的P型ZnO薄膜,我们采用了ZnO靶材进行溅射,ZnO靶材与纯锌靶材相比,有以下优点:(1)由于ZnO靶材属于半导体靶材,其溅射速率低,有利于生长出高的结晶质量的ZnO薄膜;(2)容易控制锌氧的化学计量配比沉积,消弱本征缺陷氧空位(V。),利于ZnO'NNNN型。4.3.1ZnO靶的烧结
ZnO靶是在VAF一1212真空退火炉中烧结而成的。vAF一1212真空退火炉为单室卧式真空炉,该炉可在工/一或实验室条件下完成金属材料的退火、回火等热处理工作,以及高温钎焊、烧结和某些半导体工艺等工作。VAF一1212真空退火炉主要是由真空系统、加热系统、自动控制系统等部分组成。设各具有
手动、自动控制方式。对运行过程中可能出现的意外情况如超温、断水等可具有声光报警并自动进行必要的处理。
Zn0烧结曲线设计的基本思想是:(a)在较低的温度下以CC/min的速度控制缓慢升温到400。C并恒温60min,使吸附的气体、水蒸汽等杂质可以充分脱离靶材,(b)以6℃/min的速度从400℃快速升温至800℃,在800℃恒温20miFI,使得靶材温度均匀,消除区域温差;(c)以5℃/min的速度,再升温至900。C,恒温40min进行烧结;(d)以较低(5℃/min)速度降温至800℃,以防靶材出现裂痕:(e)快速降温(6。C/min)至300℃。(f)自然冷却到室温。Zn0靶材的烧结曲线如图4一l所示。
1000
800
600
400
200
0
0100200300400
t,rain
图4-1Zn0靶的烧结曲线
4.3.2P型薄膜的制备工艺参数的选择
P型ZnO薄膜是在FJL450E型磁控与粒子束复合溅射设备上制得的。实验选用了ZnO(由99.99%的ZnO粉真空烧结而成)靶材。磁控溅射前,反应室抽真空至小于4.0×104Pa,同时衬底升温至350℃,15min后再降到溅射所需的温度300℃,以清除衬底上的气体等杂质;充入02和m溅射气体,02/Ar比为1:l进行溅射(加入02是为了弥补氧空位本征缺陷)。溅射功率为140W,溅射气体总气压保持0.5Pa,溅射时间为150min。正式溅射前,ZnO靶材先预先溅射5min以清除上面的杂质。溅射完毕后,关闸板阀,停分子泵后,继续通气至大于100Pa,同时使衬底温度加热到500。C,恒温15ta|i_rt使高掺P的硅衬底中
的P在高温下热扩散到Zn0薄膜中。15rain后,停止加热并继续通水加快冷却使得样品快速退火。
4.4结果与讨论
4.4.1X射线衍射(XRD)结果讨论
如图4—3所示,4.3a是在表面被腐蚀过的高掺磷Si(100)衬底上溅射沉积的P型ZnO薄膜的x射线衍射图,4.3b是在表面未被腐蚀过的高掺磷Si(100)衬底上溅射沉积的P型ZnO薄膜的x射线衍射图。所有测试结果均是经过Ni片滤光后的结果(衍射峰强度比不加Ni片时大约降低一倍)。X射线衍射测试结果表明所得的ZnO薄膜都具有较好的C轴择优取向。同时,利用谢乐公式计算出了ZnO薄膜的结晶尺寸(如表4.2所示),醴明结晶质量不够理想。
1600
1400
1200
1000
800暑
600=
400
2000
30354045505560
20,(。)
幽4-3ZnO薄膜的X射线衍射图
表4-2Zn0薄膜的XRD实验结果
。、.
a20(o)34.332
34.220衍射强度(a.u)14041003FWHM(o)0.560.50晶粒尺寸(tun)1618b
4.4.2光致荧光谱(PL谱)
图4—4是P型Zn0薄膜的室温荧光光谱(PL)。激发光源为xe灯,激发波长为300nm。测量显示了P型Zn0薄膜的室温荧光光谱包含两个带:中心波长位于400nm附近较强的“紫外带”和中心波长位于470nm附近很弱的的“蓝带”
【2”。紫外带很宽,波长从380rim至440nm,包含了激子复合跃迁辐射和电子从导带以下的陷阱能级(由晶粒边界形成的)到价带顶的跃迁辐射。说明P型Zn0薄膜的晶粒边界缺陷多,结晶质量不理想。由于激子是晶体的本征态,激子态的强弱,强烈地依赖晶体质量。所以发射光谱中激子发射峰不显著。
26
24
22
20
暑18
—16
14
12
10
350400450500550600
九,nm
图4-4P裂ZnO薄膜的光致荧光谱
4.4.3p-ZnO:P/n—Si:P两层结构的整流特性分析
图4—5是掺杂磷的P型ZnO年N高掺杂磷的n型si异质P—n结两层结构的I-晴寺性曲线。由图4—5可以看出,其P—ZnO:P/n—Si:PN层结构具有一定的P—n结特性,且异质p—n结的开启电压仅为2.5V左右,具有典型的P—n结整流特性。这说明用“高掺磷si},t底-ZnO膜磷扩散法”可以使磷扩散NZnO薄膜形成p型ZnO薄膜。
鼍
=100—
50一
5厂乌之l’I)
.50.一/12341U,V
.100一
.1钔.
蚓4-5异质p-n结的』一r特性曲线
(PZnO:P/n—Si:P)
4.5结论
本章应用磁控溅射的方法,首次提出在高掺磷的si衬底上沉积ZnO薄膜,通过适当的退火工艺使得Si衬底的磷扩散到ZnO薄膜中,从而达到制作P型ZnO薄膜的目的。实验选择了较低的衬底温度(300℃),是综合了提高结晶质量及防止在溅射时磷流失两方面的考虑所得出的。应用上述方法我们已经制得了P型ZnO薄膜。XRD测试结果显示了P型ZnO薄膜具有高度的c轴(002)择优取向。其结晶尺寸为18nm。这种方法制备的p型ZnO薄膜与n型si衬底之间的异质p-n结,一r特性曲线具有较低的开启电压(2.5V)和反向漏电电流。
参考文献
1.YamamotoLKatayama—YoshidaH.Growthofp-typeZincOxideFilmsby
ChemicalVaporDeposition.JpnJApplPhys,1997,36:L1453—1455.2.RyuYR,ZhuS,LookDC,eta1.Synthesisofp-typeZnOfilms.JofCrystal
Growth,2000,216:330—334.
3.RyuYR,ZhuS,BudaiJD,eta1.OpticalandstructuralpropertiesofZnOfilms
depositedonGaAsbypulsedlaserdeposition.JofApplPhys,2000,88(1):201-204.
4.RyuYR,KimWJ,WhiteHw.FabricationofhomostructuralZnOp-njunctions.JCrystGrowth,2000,219:419-422.
5.JosephM,TabataH,SackiH,eta1.Fabricationofthelowresistivep-typeZnOby
codopingmethod.PhysB,2001,302?303:140—148.
6.GuoXL,TabataH,KawaitPulsedlaserreactivedepositionofp—typeZnOfilmenhancedby
223:135-139.
7-YamamotoT’Katayama—YoshidaH.UnipolarityofZnOwithaanelectroncyclotronresonancesource.JCrystGrowth,2001,wide-bandgapand
itssolutionusingcodopingmethod.JCrystGrowth,2000,214/215:552—555.8.KazunofiMinegishi,YasushiKoiwai,YukinobuKikuchieta1.Growthofp-type
ZincOxideFilmsby
36:L1453.1455.
9.Xin—LiChemicalVaporDeposition.JpnJApplPhys,1997,Guo,Jae?HyoungChoi,Hitoshi
aTabata,eta1.FabricationandOptoelectronicPropertiesofTransparentZnOHomostructuralLight-Emitting
Diode.JpnJApplPhys,2001,40:L177—180.
10—YRRyu,WJKim,HWWhite.FabricationofhomostructuralZnOp-njunctions.
JCrystalGrowth,2000,219:419—422.
11.TomAoki,YashinoriHatanaka,andDavidClook.ZnOdiodefabricatedby
excimer-laserdoping.ApplPhys
12-Jin‘Ho
gasonLett,2000,76(22):3257.eta1.TheeffectofAr/02sputteringYang,Hyun-SikKim,Jae-HongLimthephosphorus—dopedp-typeZnOthinfilms.TheElectrochemical5
Society.2006,153(3):G242—244.
13tMJoseph,HTabata,HSaeki,eta1.Fabricationofthelow.resistivep-typeZnO
bycodopingmethod.PhysicaB,2001,302—303:140—148.
14?AVSingh,RMMehra,AWakaharaeta1.P-typeconductionincodopedZnO
thinfilms.JApplPhys,2003,396-399.
15.JMBian,XMLi,XDYu,eta1.DepositionandelectricalpropertiesofN—In
codopedp-typeZnOfilmsbyultrasonicspraypyrolysis.AppliedPhysicsLetters.2004,84(4):541—543.
I6.JMBian,XMLi,CYZhang,eta1.Synthesisandcharacterizationof
two—layer’structuredZnOpn
Physhomojunctionsbyultrasonicspraypyrolysis.ApplLett,2004,84(19):3783.3785.
曾昱嘉等.真流反应磁控溅射Al,N共掺方法生长D型17.袁国栋,叶志镇,
ZnO薄膜及其特性.半导体学报,2004,25(6):668—673.
18-吕建国,叶志镇,诸葛飞等.N-A1共掺Zn0薄膜的p型传导特性.半导体
学报,2005,26(4):730—733.
19.GuangXiong,JohnWikinson,BrianMischuck,eta1.Controlofp.andn—type
conductivityinsputterdepositionofundopedZnO.ApplPhysLett.2002,80(7):】195一】197.
20-许小亮,杨晓杰,谢家纯等.以硅为衬底的ZnOp-n结的制备及其结构、
光学和电学特性.发光学报,2004,25(3):295—298.
21t王卿璞,张德恒,薛忠营等.射频磁控溅射法制备znO薄膜的发光特性.发光学报,2003,24(1):69—72
第5章全文总结
本论文主要以射频磁控溅射法制备的ZnO薄膜及掺杂的ZnO薄膜为研究对象,利用x射线衍射仪、原子力显微镜、荧光分光光度计等对制备的样品进行结构及光学性质进行了表征。并对P型ZnO薄膜的制备及P型ZnO薄膜与n型Si衬底之间的异质p-n整流特性进行了研究。
第1章介绍了ZnO的结构特性及ZnO薄膜材料的应用,并对国内外的研究状况进行了总结。
第2章简单介绍了薄膜的生长理论及溅射的基本原理,并总结了可用于制备ZnO薄膜的主要制备技术的原理及其特点。
第3章利用射频磁控反应溅射技术分别在石英玻璃和掺杂P的n型单晶硅衬底上低温200℃生长出具有有高度(002)晶面取向的ZnO外延薄膜。在这一章里主要研究了用反应射频磁控溅射技术制备ZnO薄膜时,衬底、溅射气氛和退火对薄膜结晶质量及光学性质的影响。(1)采用低温200℃生长,发现在适当的工艺条件下,在硅基上能够形成几十到几百纳米的氧化锌准六角柱,而玻璃基底上则没有,并讨论了这一结果的形成机制。(2)发现ZnO薄膜的结构和光学性质对溅射气氛(既OJAr)有很强的依赖关系,利用溅射技术的基本原理、薄膜生长原理及半导体缺陷发光等,联合分析了这一实验现象产生的机制,并总结了一套具体的制各高质量ZnO薄膜的工艺参数。(3)所有样品经450℃退火后,结晶质量提高,表面更平整,吸收谱激子峰(363nm)加强,同时出现了402nm的本征氧空位紫光发射。低温生长ZnO薄膜对“高掺磷Si衬底--ZnO膜磷扩散法”制备P型ZnO薄膜有重要的意义。
第4章应用磁控溅射的方法,首次采用在高掺磷的Si衬底上沉积ZnO薄膜,通过适当的退火工艺使得Si衬底的磷扩散到ZnO薄膜中制作P型ZnO薄膜的方法成功制备了P型ZnO薄膜。实验综合了提高结晶质量及防止在溅射时磷流失两方面的考虑,提出了以较低的衬底温度(300℃)生长ZnO的方法。XRD测试结果显示了高度的c轴择优取向,其结晶尺寸为18nm。P型ZnO薄膜与n型si衬底之间的异质p-n结的卜r特性曲线具有较低的开启电压(2.5V)和反向漏电电流。这表明ZnO薄膜已经被有效的进行了P型磷掺杂。
攻读学位期间完成的论文
1.制备工艺对ZnO薄膜的结构及其光学性质的影响赵银平,丁瑞钦,汪河洲等.已被《电子元件与材料"录用
致谢
本文是在导师汪河洲教授的悉心指导下完成的。导师渊博的专业知识、孜孜不倦的探索精神和一丝不苟的治学态度将使我在今后的工作中受益非浅。在此谨向导师表示深深的敬意和衷心的感谢!
特别感谢丁瑞钦教授、王忆副教授和朱慧群老师对我的学习和工作提供了数不尽的帮助和指点,帮助我克服科研道路上的重重难关,我的工作成果的点点滴滴都少不了他们的贡献。还要感谢丁才蓉老师在实验上的帮助及支持。
感谢范海华师姐和梁冠全同学在实验上的帮助,感谢陈星同学和邹慧同学在生活上和学习上给我的帮助,感谢我实验室的所有同学,在这个团体中我学到了许许多多知识和得到了各种支持。
多年来,父母对我始终如一的爱护、支持和无私的奉献是我力量的源泉,他们的养育之恩已不是一声感谢可以表达的。
赵银平2006年5月
原创性声明
本人郑重声明:所呈交的学位论文,是本人在导师的指导下及老师、同学的协助下,独立进行研究工作所取得的成果。除文中已经注明引用的内容外,本论文不包含任何其他个人或集体已经发表或撰写过的作品成果。对本文的研究做出重要贡献的个人和集体,均己在文中以明确方式标明。本人完全意识到本声明的法律结果由本人承担。
学位论文作者签名:起银年日期:加石年岁月:}D日

ZnO薄膜和p型ZnO薄膜的磁控溅射法制备及其性质研究
作者:
学位授予单位:赵银平中山大学
相似文献(10条)
1.期刊论文 谷建峰.刘志文.刘明.付伟佳.马春雨.张庆瑜.Gu Jian-Feng.Liu Zhi-Wen.Liu Ming.Fu Wei-Jia.MaChun-Yu.Zhang Qing-Yu Si(001)基片上反应射频磁控溅射 ZnO薄膜的两步生长方法 -物理学报2007,56(4)
利用反应射频磁控溅射技术,采用两步生长方法制备了ZnO薄膜,探讨了基片刻蚀时间和低温过渡层沉积时间对ZnO薄膜生长行为的影响.研究结果表明,低温ZnO过渡层的沉积时间所导致的薄膜表面形貌的变化与过渡层在Si(001)表面的覆盖度有关.当低温过渡层尚未完全覆盖基片表面时,ZnO薄膜的表面岛尺度较小、表面粗糙度较大,薄膜应力较大;当低温过渡层完全覆盖Si(001)基片后,ZnO薄膜的表面岛尺度较大、表面粗糙度较小,薄膜应力较小.基片刻蚀时间对薄膜表面形貌的影响与低温过渡层的成核密度有关.随着刻蚀时间的增加,ZnO薄膜的表面粗糙度逐渐下降,表面形貌自仿射结构的关联长度逐渐减小.
2.学位论文 汪冬梅 ZnO薄膜和Al掺杂ZnO(ZAO)薄膜的射频磁控溅射制备及其性能研究 2006
ZnO是一种Ⅱ-Ⅵ族的宽带隙直接带结构的多功能材料,为六角纤锌矿结构。ZnO薄膜由于具有优异的压电、光电、气敏、压敏等特性,近年来受到广泛关注。Al掺杂的ZnO(ZAO)透明导电膜作为一种重要的光电子信息材料也得到了广泛的研究,ZAO薄膜具有与目前已得到广泛应用的ITO薄膜可比拟的光学、电学性质,而且在高温条件下,它的成分不易与氢发生互扩散,因此在活性氢和氢等离子体环境中化学稳定性高,不易使太阳能电池材料活性降低,是最有开发潜力的透明导电薄膜,可望成为ITO薄膜最佳的替代者,推动廉价太阳能电池的发展。
本文利用射频磁控溅射技术完成了ZnO薄膜和Al掺杂ZnO(ZAO)薄膜的制备,并对所制备的薄膜进行了退火处理。利用X射线衍射(XRD)、扫描电子显微镜(SEM)、X射线光电子能谱(XPS)、荧光光谱仪、光谱仪、四探针测试仪等对制备的ZnO薄膜进行了表征和性能研究。
研究表明,制备工艺尤其是衬底温度和退火处理能显著影响薄膜的晶体、光学和电学性能。就ZnO薄膜而言,衬底温度为300℃时,薄膜的择优取向最强,空气中500℃退火能使薄膜的结晶性能最好,而无论是原位沉积薄膜还是退火后的薄膜的可见光区平均透光率均超过85%;对Si(111)衬底上沉积的ZnO薄膜进行退火处理,薄膜的结晶质量得到提高,与深能级发射有关的缺陷浓度有所减少。对于ZAO薄膜,原位沉积的薄膜电阻率可达2.59Ωcm,可见光区透过率约为70%。薄膜的低电阻率是通过Al掺杂和薄膜中的化学计量比偏移获得,但是Al掺杂在降低薄膜电阻率的同时会引起杂质散射,因此ZAO薄膜的可见光区透过率较ZnO薄膜会有所下降,光学带隙由于Burstein-Moss效应会有所增大。500℃纯Ar气氛中退火1h后,ZAO薄膜的透光性能和导电性能均有所改善,ZAO薄膜可见光区平均透过率从70%提高到80%左右,薄膜的电阻率从2.59Ωcm降低到0.13Ωcm。
3.期刊论文 朱慧群.丁瑞钦.ZHU Hui-qun.DING Rui-qin 射频磁控溅射掺氮ZnO薄膜的制备与表征 -半导体技术2006,31(7)
以ZnO为靶材,采用射频磁控溅射法,在衬底温度为450℃、混合气体压强为1.3Pa的条件下,在石英玻璃和抛光单晶硅衬底上沉积了一系列呈六角纤锌矿结构、沿(0002)晶面高度取向生长的ZnO薄膜.利用X射线衍射、四探针、原子力显微镜、吸收光谱和光致荧光光谱等实验分别对薄膜样品的晶体结构、表面形貌和光电特性进行了分析表征.结果表明,氮对ZnO薄膜的缺陷有明显的钝化作用,气体组分、溅射功率是影响ZnO薄膜沿C轴择优取向生长、结构特征和光电性质的重要因素.
4.期刊论文 黄飞.孙仲亮.孟凡明.孙兆奇.HUANG Fei.SUN Zhong-liang.MENG Fan-ming.SUN Zhao-qi 射频磁控溅射ZnO薄膜的微结构与光学特性 -真空电子技术2008,""(2)
研究了膜厚对ZnO薄膜微结构和光学性能的影响.采用射频磁控溅射法在单晶硅(111)和玻璃基片上制备了不同厚度的ZnO薄膜.通过X射线衍射、原子力显微镜和紫外可见光谱对薄膜进行了表征.结果表明薄膜结晶性能良好,在(002)晶面具有明显的c轴取向.随着薄膜厚度的增加,透射率下降,吸收边红移,禁带宽度逐渐减小.
5.学位论文 邱骏 射频磁控溅射法制备TiO<,2>,ZnO薄膜及性质研究 2007
在材料科学的各个分支中,薄膜材料科学的发展一直占据了极为重要的地位。TiO2,ZnO薄膜具有优良的介电、压电、气敏和光催化等功能,在微电子、光学、传感器和光催化等方面有着重要的应用。
分别以高纯金属钛、锌为靶材,氧气为反应活性气体,采用射频磁控溅射法制备金属薄膜以及以射频磁控反应溅射法沉积金属氧化物薄膜,对制备的金属薄膜在不同的温度下空气气氛中进行热处理,开始反应生成各自的金属氧化物。对以射频反应磁控溅射法沉积金属氧化物薄膜在马弗炉中不同温度下加热进行退火处理。
沉积的金属钛薄膜在马弗炉中加热,易向金红石相的。TiO2薄膜转变,而沉积的非晶氧化钛薄膜在退火条件下容易向锐钛矿相转变。金属锌薄膜在马弗炉中加热反应后生成纤锌矿相氧化锌薄膜,但是薄膜表面比较疏松起翘。
采用紫外-可见分光谱测试TiO2、ZnO薄膜的透射率,研究氧气流量、退火温度对薄膜透射率的影响;以扫描电镜考察氧气流量变化对TiO2、ZnO薄膜表面形貌的影响;以拉曼光谱(Raman)和X射线衍射(XRD)对薄膜的晶型形态进行了测试和分析。
对所制备得到的TiO2薄膜进行亲水性和光催化性能测试。
6.期刊论文 高晓红.王超.马占敖.迟耀丹.杨小天.GAO Xiao-hong.WANG Chao.MA Zhan-ao.Chi Yao-dan.YANGXiao-tian ZnO薄膜的射频磁控溅射制备及性能研究 -光机电信息2008,25(12)
采用射频磁控溅射法在玻璃衬底上制备出高质量的ZnO薄膜.对薄膜的结构和性能进行了研究.所制备的ZnO是具有六角纤锌矿结构的多晶薄膜,最佳择优取向为(002)方向.ZnO薄膜的霍尔迁移率和载流子浓度分别为8×104m2/(V·s)和11.3×1020 cm-3.
7.学位论文 余花娃 射频磁控溅射法制备氧化锌薄膜及其特性的研究 2007
ZnO是一种新型的Ⅱ-Ⅵ族直接带隙化合物半导体,禁带宽度为3.37eV,激子束缚能为60meV具有六方纤锌矿结构。ZnO薄膜具有广泛的应用,如ZnO薄膜可以制成表面声波谐振器、压电器件、压敏器件、透明电极、气敏传感器、导电膜等。近年来,随着短波器件的广泛应用,直接宽带半导体材料的研究越来越受人们的重视,对氧化锌薄膜材料的研究和开发在国内外科学界及工业部门引起了极大的关注和兴趣。
ZnO薄膜制备的主要方法有:磁控溅射、金属有机化学气相沉积、脉冲激光沉积、分子束外延、电子束蒸发沉积、喷雾热分解、溶胶.凝胶法、薄膜氧化法等。各种方法各有优缺点。根据需要制备相应的高质量的薄膜是ZnO薄膜应用的关键,同时制备成本也是必须考虑的重要因素。通常认为理想ZnO薄膜具有高的c轴择优取向。磁控溅射在最佳条件下可以得到均匀、致密、有良好的c轴取向性和可见光波段透明性好等优点的薄膜,使得它成为在ZnO制备中研究最多并且使用最广泛的方法。本课题采用RF反应磁控溅射制备了ZnO薄膜并对其进行探索性研究。研究内容主要包括:射频磁控溅射工艺条件对ZnO薄膜结构特性和表面形貌的影响、对ZnO薄膜光学特性的影响,以及ZnO发光机理的探讨。薄膜的结构特性用XRD进行了分析,薄膜的表面形貌通过原子力显微镜进行表征,薄膜的透射光谱用紫外.可见双光束分光光度计进行测量,发光性质用光栅光谱仪进行了分析。
研究结果表明利用射频磁控溅射法工艺,在功率为100W,真空度为2×10<'-4>Pa,靶基距为70mm左右,溅射时间为60分钟,基片为单面抛光的(100)硅片,基片温度200℃、氩氧比为2:3的条件下得到了结晶质量良好的ZnO薄膜;通过退火可以使薄膜应力得到驰豫,降低缺陷浓度,改善薄膜的结构特性。本实验采用射频磁控溅射的方法,探索出制备ZnO薄膜的最佳工艺条件,最终在(100)硅衬底基片上制备出了较高c轴取向的ZnO薄膜。但是由于试验条件限制,在发光试验的测试中,我们只观察到了在350nm处的一个明显的发射峰和在480nm处的微弱的峰,对此本文也进行了探索性分析。
8.期刊论文 宋学萍.周旭.孙兆奇.SONG Xue-ping.ZHOU Xu.SUN Zhao-qi 射频磁控溅射ZnO薄膜的结构和应力特性 -合肥工业大学学报(自然科学版)2007,30(9)
用JGP560I型超高真空多功能磁控溅射仪在Si(111)衬底上制备了ZnO薄膜.采用X-Ray衍射仪和电子薄膜应力分布测试仪等对其微结构和应力进行了测试分析.研究结果表明,ZnO薄膜具有良好的c轴择优取向;随着薄膜厚度的增加,薄膜中的平均应力减少;膜厚为744 nm时平均应力、应力差均最小,分别为
5.973×108 Pa、6.159×108 Pa,应力分布较均匀.
9.期刊论文 刘玉华.孙汪典 ZnO薄膜的射频磁控溅射法制备及特性 -暨南大学学报(自然科学与医学版)2004,25(3) 利用射频磁控溅射镀膜工艺,在石英玻璃衬底上成功制备了ZnO薄膜. 采用原子力显微镜、X射线衍射、拉曼光谱、荧光分光光度计及椭偏等检测手段对其特性进行了测试、分析. 研究结果表明:该薄膜具有良好的C轴取向结晶度;最佳激发波长为265.00 nm,光致发光峰分别位于362.00、421.06和486.06nm;437 cm-1是ZnO晶体的特征拉曼峰,该峰的出现与最强的X射线衍射(002)峰相对应;薄膜折射率为2.01.
10.学位论文 顾金宝 ZnO薄膜的制备与性能研究 2007
ZnO薄膜是一种具优良的压电、光电、气敏、压敏等性质的材料,在透明导体、发光元件、太阳能电池窗口材料、光波导器、单色场发射显示器材料、高频压电转换、表面声波元件、微传感器以及低压压敏电阻器等方面具有广泛的用途.ZnO薄膜的制备方法多样,各具优缺点,而薄膜性质的差异不仅取决于不同的掺杂组分,并与制备工艺紧密相关.本文研究采用两种不同的方法制备ZnO薄膜:一是采用射频磁控溅射制各ZnO薄膜;二是采用离子束溅射锌膜然后在氧气氛炉中退火氧化制备ZnO薄膜.
第一章介绍了ZnO薄膜的晶体结构、制备方法、性能以及关于ZnO薄膜的国内外的研究进展概况.
第二章研究射频磁控溅射和离子束溅射制备ZnO薄膜.内容包括射频磁控溅射的基本原理和离子束溅射的基本原理,射频磁控溅射ZnO薄膜制备的基本过程,离子束溅射制备ZnO薄膜的过程.
第三章研究射频磁控溅射工艺参数以及退火工艺对ZnO薄膜结构、形貌的影响.工艺参数方面主要是通过对沉积时间分别为30min和60min的ZnO薄膜的结构与形貌进行对比分析,发现随着溅射时间的增加,薄膜的结晶性得到改善,颗粒尺寸增加,薄膜表面粗糙度降低,其次退火工艺方面研究了未退火的ZnO薄膜和经600℃退火的ZnO薄膜结构与形貌上的区别,发现经退火处理的ZnO薄膜结构致密,颗粒尺寸均匀化,表面粗糙度降低.
第四章研究了采用离子束溅射法制备ZnO薄膜.研究了工艺参数,退火温度,保温时间,衬底,单枪溅射以及二次溅射处理对ZnO薄膜结构、形貌、导电性的影响.工艺参数方面主要对溅射时间分别为30,60,120min的ZnO薄膜结构与形貌进行分析,发现随着溅射时间增加,薄膜的结晶性得到改善,颗粒尺寸变大,表面粗糙度下降;分析了在石英玻璃衬底上的ZnO薄膜在不同温度下退火的结晶性,发现随着退火温度的改变,薄膜的生长取向有所改变;退火工艺中保温时间增加导致薄膜的颗粒尺寸变大,薄膜表面粗糙度下降;不同的衬底导致薄膜的生长情况也不一样;通过对比单枪溅射和二次溅射制备的ZnO薄膜的结构与形貌,发现二次溅射后的薄膜XRD峰强度减弱,但是二次溅射后的ZnO薄膜的表面粗糙度降低.
第五章通过对比射频和离子束溅射两种方法制备的ZnO薄膜的结构,表面形貌以及导电性,发现射频磁控溅射制备的ZnO薄膜在取向性,表面粗糙度以及电阻率方面的表现优于离子束溅射制备的ZnO薄膜.
本文链接:http://d..cn/Thesis_Y924447.aspx
授权使用:吉林大学(jldx),授权号:e2c4f0a9-c386-4806-b4c0-9df2011de336
下载时间:20xx年9月15日
-
磁控溅射镀膜实验报告
近代物理实验磁控溅射镀膜宋爽核1220xx011723指导老师王合英20xx524摘要本实验根据气体辉光放电和磁场约束电子运动的原…
-
磁控溅射镀膜多年经验总结
黑色实验总结1材料对比TiCTiC是最常见最经济的一种黑色硬质膜颜色可以做到比较深耐磨性能也很好但其色调不够纯正总是黑中略带黄色并…
-
薄膜实验报告,磁控溅射与高真空成膜
电子科技大学实验报告姓名郭章学号20xx054020xx2指导教师许向东日期20xx年6月12日一实验室名称光电楼薄膜制备实验室二…
-
磁控溅射镀膜的简介及其实际操作
磁控溅射镀膜的简介及其实际操作作者徐超群作者单位乐山师范学院物理与电子工程系摘要溅射技术的最新成就之一是磁控溅射对于二级溅射偏压溅…
-
实验三十六 磁控溅射法制备导电薄膜
电子材料与元器件专业实验指导书实验三十六磁控溅射法制备导电薄膜实验名称磁控溅射法制备导电薄膜实验项目性质综合训练所涉及课程薄膜电子…
-
无水乙醇的制备实验报告
化学工程学院实验专班姓日指导机化学实验报告名称无水乙醇的制备业化学工程与工艺级化工136班名白慧超学号134020xx636期20…