5.半导体PN结的物理特性及弱电流测量
电学五、半导体PN结的物理特性及弱电流测量
半导体PN结电流-电压关系特性是半导体器件的基础,也是半导体物理学和电子学教学的重要重要基础内容之一。本实验采用一个简单的电路测量通过PN结的扩散电流与PN结电压之间的关系,并通过数据处理,证明PN结的电流与电压遵循指数关系;在测得PN结器件温度的情况下,还可以从实验得到波尔兹曼常数。
一、实验目的
1、在室温时,测量PN结电流与电压关系,证明此关系符合指数分布规律。 2、在不同温度条件下,测量玻尔兹曼常数。
3、学习用运算放大器组成电流-电压变换器测量弱电流。
4、测量PN结电压与温度关系,求出该PN结温度传感器的灵敏度。
二、实验仪器
1、PN结物理特性测定仪,见图1。
2、TIP31型三极管(带三根引线)1个,3DG三极管1个。 3、ZX21型电阻箱1只。

图1 PN结物理特性测定仪面版示意图
三、实验原理
1、PN结伏安特性及玻尔兹曼常数测量由半导体物理学可知,PN结的正向电
流-电压关系满足:
I=I0[e eU /kT-1] (1)
306
式(1)中I是通过PN结的正向电流,I0是反向饱和电流,在温度恒定是为常数,T是热力学温度,e是电子的电荷量,U为PN结正向压降。由于在常温(300K)时,kT/e≈0.026v ,而PN结正向压降约为十分之几伏,则e
eU/kT>>1,(1)式括号内-1项完全可以忽略,于是有:
I=I0e eU/kT (2)
也即PN结正向电流随正向电压按指数规律变化。若测得PN结I-U关系值,则利用(1)式可以求出e/kT。在测得温度T后,就可以得到e/k常数,把电子电量作为已知值代入,即可求得玻尔兹曼常数k。
在实际测量中,二极管的正向I-U关系虽然能较好满足指数关系,但求得的常数k往往偏小。这是因为通过二极管电流不只是扩散电流,还有其它电流。一般它包括三个部分:[1]扩散电流,它严格遵循(2)式;[2]耗尽层符合电流,它正比于e eU/2kT;[3]表面电流,它是由Si和SiO2界面中杂质引起的,其值正比于eeU/mkT,一般m>2。因此,为了验证(2)式及求出准确的e/k常数,不宜采用硅二极管,而采用硅三极管接成共基极线路,因为此时集电极与基极短接,集电极电流中仅仅是扩散电流。复合电流主要在基极出现,测量集电极电流时,将不包括它。本实验中选取性能良好的硅三极管(TIP31型),实验中又处于较低的正向偏置,这样表面电流影响也完全可以忽略,所以此时集电极电流与结电压将满
足(2)式。实验线路如图2所示。
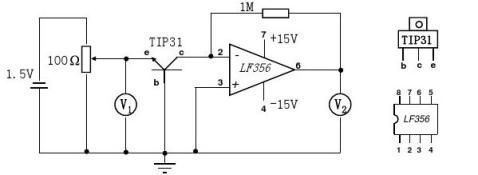
图2 PN结扩散电源与结电压关系测量线路图
2、弱电流测量
过去实验中10-6A-10-11A量级弱电流采用光点反射式检流计测量,该仪器灵敏度较高约10-9A/分度,但有许多不足之处。如十分怕震,挂丝易断;使用时稍有不慎,光标易偏出满度,瞬间过载引起引丝疲劳变形产生不回零点及指示差变大。使用和维修极不方便。近年来,集成电路与数字化显示技术越来越普及。高输入阻抗运算放大器性能优良,价格低廉,用它组成电流-电压变换器
307
测量弱电流信号,具有输入阻抗低,电流灵敏度高。温漂小、线性好、设计制作简单、结构牢靠等优点,因而被广泛应用于物理测量中。
LF356是一个高输入阻抗集成运算放大器,用它组成电流-电压变换器(弱电流放大器),如图3所示。其中虚线框内电阻Zr为电流-电压变换器等效输入阻抗。由图3可,运算放大器的输入电压U0为:
U0=-K0Ui (3)
式(3)中Ui为输入电压,K0为运算放大器的开环电压增益,即图3中电阻Rf??时的电压增益,Rf称反馈电阻。因为理想运算放大器的输入阻抗ri ??,所以信号源输入电流只流经反馈网络构成的通路。因而有:
IS=(Ui-UO)/Rf=Ui(I+KO)/Rf (4) 由(4)式可得电流-电压变换器等效输入阻抗Zr为
Zr=Ui/Is=Rf/(1+K0)≈Rf/K0
(5)
由(3)式和(4)式可得电流-电压变换器输入电流Is输出电压U0之间得关系式,即: IS=-(1+K0)/Rf=-U0(1+1/K0)/Rf=-U0/Rf
(6)
由(6)式只要测得输出电压U0和已知Rf值,即可求得IS值。以高输入阻抗集成运算放大器LF356为例来讨论Zr和IS值得大小。对LF356运放的开环增益K0=2×105,输入阻抗ri≈1012Ω。若取Rf为1.00MΩ,则由(5)式可得:
Zr=1.00×106Ω/(1+2×105)=5Ω
若选用四位半量程200mV数字电压表,它最后一位变化为0.01mV ,那么用上述电流-电压
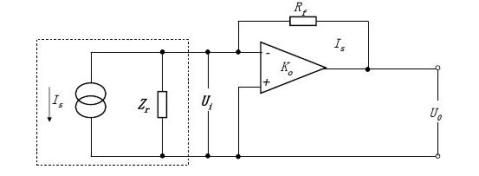
U0K0图3 电流-电压变换器
变换器能显示最小电流值为:
(IS)min=0.01×10-3V/(1×106Ω)=1×10-11A
由此说明,用集成运算放大器组成电流-电压变换器测量弱电流,具有输入阻抗小、灵敏度高的优点。
3、PN结的结电压
Ube与热力学温度T关系测量。 308
当PN结通过恒定小电流(通常电流I=1000μA),由半导体理论可得
近似关系:
Ube?ST?UgoUbe与T (5)
oU式中S≈-2.3mV/C为PN结温度传感器灵敏度。由go可求出温度0K时半
导体材料的近似禁带宽度
Ego=qUgo。硅材料的Ego约为1.20eV。
四、实验内容
1、
(Ic?Ube关系测定,并进行曲线拟合求经验公式,计算玻尔兹曼常数。Ube?U1)
(1)实验线路如图3所示。图中U1为三位半数字电压表,U2为四位半数字电压表,TIP31型为带散热板的功率三极管,调节电压的分压器为多圈电位器,为保持PN结与周围环境一致,把TIP31型三极管浸没在盛有变压器油干井槽中。变压器油温度用铂电阻进行测量。
(2)在室温情况下,测量三极管发射极与基极之间电压U1和相应电压U2。在常温下U1的值约从0.3V至0.42V范围每隔0.01V测一数据点,约测10多个数据点,至U2值达到饱和时(U2值变化较小或基本不变),结束测量。在记数据开始和记数据结束都要同时记录变压器油的温度?,取温度平均值?。
(3)曲线拟合求经验公式:运用最小二乘法,将实验数据分别代入线性回归、指数回归、乘幂回归这三种常用的基本函数(它们是物理学中最常用的基本函数),然后求出衡量各回归程序好坏的标准差δ。对已测得的U1和U2各对数据,以U1为自变量,U2作因变量,分别代入:
bbU1U?aU?bU?aeU?aU22121①线性函数;②乘幂函数;③指数函数。求?
出各函数相应的a和b值,得出三种函数式,究竟哪一种函数符合物理规律必须用标准差来检验。办法是:把实验测得的各个自变量U1分别代入三个基本函数,得到相应因变量的预期值U2*,并由此求出各函数拟合的标准差:
*2[?(Ui?Ui)/n]
i?1n δ=
式中n为测量数据个数,Ui为实验测得的因变量,Ui*为将自变量代入基本函数的因变量预期值,最后比较哪一种基本函数为标准差最小,说明该函数拟合得最好(该部分内容见教材第20-23页)。
(4)计算e/k常数,将电子的电量作为标准差代入,求出玻尔兹曼常数并与公认值进行比较。
309
2、Ube?T关系测定,求PN结温度传感器灵敏度S.
(1)实验线路如图5所示,测温电路如图6所示。其中数字电压表V2通过双刀双向开关,既作测温电桥指零用,又作监测PN结电流,保持电流I=100μA用。
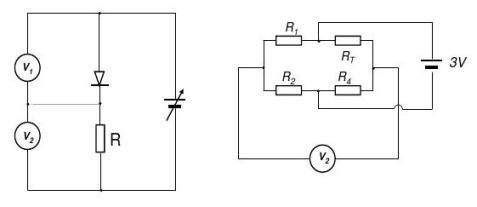
图5 图6
(2)通过调节图5电路中电源电压,使上电阻两端电压保持不变,即电流I=100μA。同时用电桥测量铂电阻RT的电阻值,通过查铂电阻值与温度关系表(见附表),可得恒温器的实际湿度。从室温开始每隔5℃-10℃测一定V1)与温度t(℃)关系,求得
(3)由实验数据作Ube?TUbe?TUbe值(即关系。(至少测6点以上数据) 直线图,并计算该直线斜率(该斜率即为PN结温度传感器灵敏度S)。
五、注意事项:
1、数据处理时,对于扩散电流太小(起始状态)及扩散电流接近或达到饱和时的数据,在处理数据时应删去,因为这些数据可能偏离公式(2)。 2、必须观测恒温装置上温度计读数,待TIP31三极管温度处于恒定时(即处于热平衡时),才能记录U1和U2数据。
4、由于各公司的运算放大器(LF356)性能有些差异,在换用LF356时,有可能同台仪器达到饱和电压U2值不相同。
六、实验数据记录
1、Ic?Ube关系测定,曲线拟合求经验公式,计算玻尔兹曼常数。
室温条件t1t2= t= ℃
310


(以U1为自变量,U2为因变量,分别进行线性函数、乘幂函数和指数函数的拟合)
由上表得出结论,说明PN结扩散电流-电压关系遵循什么规律。
计算玻尔兹曼常数
由表1数据得
e/kCK/J
则
k?
ee/kJ/K
Ube?T2、电流I=100uA时,
表2 Ube?T关系测定,求PN结温度传感器的灵敏度S. 关系测定
七、本实验可入手的创新点
由表2数据作Ube –T直线图,并计算该直线斜率(该斜率即为PN结温度传感器的灵敏度S)。
参考资料:
1、沈元华、陆申龙 主编. 基础物理实验. 北京:高等教育出版社 2003.12:193-196 2、吕斯骅 段家忯 主编. 基础物理实验. 北京:高等教育出版社 2003.3:307
徐华伟 谭春光 朱亚辉 陆申龙 低温半导体PN结的物理特性及玻尔兹曼常数的测量,学物理实验,1999,12(2):1-3
312

第二篇:PN结原理
p-n结基本概念是解决许多微电子和光电子器件的物理基础。对于许多半导体器件问题的理解不够深透,归根到底还在于对于p-n结概念的认识尚有模糊之处的缘故。
因为p-n结的一个重要特点就是其中存在有电场很强的空间电荷区,故p-n结的形成机理,关键也就在于空间电荷区的形成问题;p-n结的能带也就反映了空间电荷区中电场的作用。
载流子的转移:
p型半导体和n型半导体在此需要考虑的两个不同点即为(见图(a)):①功函数W不同;②主要(多数)载流子种类不同。因此,当p型半导体和n型半导体紧密结合而成的一个体系——p-n结时,为了达到热平衡状态(即无能量转移的动态平衡状态),就会出现载流子的转移:电子从功函数小的半导体发射到功函数大的半导体去,或者载流子从浓度大的一边扩散到浓度小的一边去。对于同质结而言,载流子的转移机理主要是浓度梯度所引起的扩散;对于异质结(例如Si-Ge异质结,金属-半导体接触)而言,载流子的转移机理则主要是功函数不同所引起的热发射。
空间电荷和内建电场的产生:
现在考虑同质p-n结的形成:在p型半导体与n型半导体的接触边缘附近处(即冶金学界面附近处),当有空穴从p型半导体扩散到n
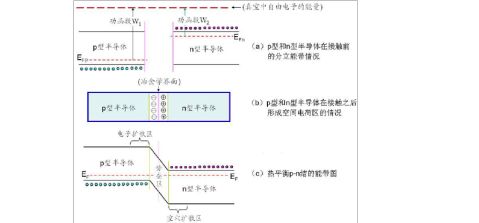
型半导体一边去了之后,
就在n型半导体中增加了正电荷,同时在p型半导体中减少了正电荷,从而也就在p型半导体中留下了不能移动的电离受主中心——负离子中心;与此同时,当有电子从n型半导体扩散到p型半导体一边去了之后,就在p型半导体中增加了负电荷,同时在n型半导体中减少了负电荷,从而也就在n型半导体中留下了不能移动的电离施主中心——正离子中心。这就意味着,在p型半导体一边多出了负电荷(由电离受主中心和电子所提供),在n型半导体一边多出了正电荷(由电离施主中心和空穴所提供),这些由电离杂质中心和载流子所提供的多余电荷即称为空间电荷,它们都局限于接触边缘附近处,以电偶极层的形式存在,如图(b)所示。
由于在两种半导体接触边缘的附近处存在着正、负空间电荷分列两边的偶极层,所以就产生出一个从n型半导体指向p型半导体的电场——内建电场。在此,内建电场仅局限于空间电荷区范围以内,在空间电荷区以外都是不存在电场的电中性区。
p-n结的势垒和能带:
因为在p-n结界面附近处存在着内建电场,而该内建电场的方向正好是阻挡着空穴进一步从p型半导体扩散到n型半导体去,同时也阻挡着电子从n型半导体进一步扩散到p型半导体去。于是从能量上来看,由于空间电荷-内建电场的出现,就使得电子在p型半导体一边的能量提高了,同时空穴在n型半导体一边的能量也提高了;而在界面附近处产生出了一个阻挡载流子进一步扩散的势垒——p-n结势垒。根据内建电场所引起的这种能量变化关系,即可画出p-n结的能带图,如图(c)所示。在达到热平衡之后,两边的Fermi能级(EF)是拉平(统一)的。能带的倾斜就表示着电场的存在。
①势垒高度:
实际上,在p-n结界面处的内建电场就使得p型半导体与n型半导体之间产生了电位差——内建电势差(或内建电压)。电场越强,内建电势差就越大。此内建电势差所对应的能量差(能量差=电势差×电子电荷),即为p-n结的势垒高度。虽然势垒高度并不直接反映的内建电场的大小,因为内建电场在势垒区中的分布可能不一定均匀(决定于空间电荷密度的分布),然而内建电场分布曲线下面的面积却总是一定的(即内建电压不变)。所以,电场越强,势垒高度也就越大。
注意: a)从热平衡时p-n结能带图的形成来看(比较图(a)和图 (c)),势垒高度实际上也就等于两边半导体在接触之前的Fermi能级之差,即:势垒高度= EFn - EFp。 b)内建电势差是p-n结为了达到热平衡、而在内部自动产生出来的一个电势差,只是局限于p-n结界面附近;该电势差在外面不可能表现出来,因为这时p-n结体系是处于热平衡状态,不可能对外做功。
因为p-n结中内建电势差的存在,就使得电子在p型半导体一边的势能要高于n
型半导体一边,空穴的势能恰恰相反。而电子的势能可看成是导带底能量,空穴的势能可看成是价带顶能量,所以p-n结两边的整个能带的高低,就相差一个与此内建电势差相对应的势能差——p-n结的势垒高度。由于电场等于势能梯度,因此能带在势垒区中是倾斜的,在以外是水平的,如图(c)所示。
②势垒厚度:
存在内建电场的区域就是势垒区,势垒区的厚度(或宽度)与半导体的掺杂浓度等因素有关。可以想见,在掺杂浓度一定(即空间电荷密度一定)的条件下,内建电场越强、势垒高度越大,势垒厚度也就将越大;但势垒厚度与势垒高度之间不是简单的线性关系,这决定于掺杂浓度的分布形式(突变结近似为平方根关系,缓变结近似为立方根关系)。
p-n结的基本特点:
①在单独的n型半导体或者p型半导体中,电子的势能都是一样的(可以认为都是导带底能量),空穴亦然(价带顶能量);但是在热平衡的p-n结中,因为n型和p型这两边之间存在着内建电势差,则电子在n型半导体中和在p型半导体中的势能就不一样了,所以导带底以及价带顶在两边的高低也就有所不同了(即p型半导体一边的整个能带都要高于n型半导体一边的整个能带)。
②对于一般的p-n结,它的势垒区与空间电荷区是重合的(但是,pin结的势垒区要比空间电荷区宽得多),因此只有在p-n结势垒区中才存在着内建电场,在势垒区以外是电中性区。从而,p-n结势垒区中的能带是倾斜的,载流子在势垒区以内的运动主要靠漂移;但在势垒区以外的能带是水平的,载流子的运动主要靠扩散。对于势垒区以外、两边的电中性区,其中一个扩散长度大小的范围特称为扩散区,因为这是少数载流子能够扩散到势垒区边缘的一个有效范围,在此范围以外的电中性区中的少数载流子就难以扩散到势垒区。
③因为势垒区是在冶金学界面附近处的一个区域,其厚度一般较薄,所以势垒区中的内建电场通常都较强;而内建电场起着把导带电子驱赶到n型半导体、把价带空穴驱赶到p型半导体中去的作用,于是势垒区中留下的载流子数目往往很少。从而,在一定的近似程度上,就可以认为势垒区中的载流子完全被驱赶出去了——载流子被耗尽了,即认为势垒区为一个耗尽层。在耗尽层近似下,p-n结中的空间电荷就完全看成是由电离杂质中心所提供的。
PN结原理: P-N 结的势垒高度和势垒厚度
(1)为什么p-n结势垒厚度随着掺杂浓度的提高而变薄?
——因为在热平衡时,一定的空间电荷就正好能够产生抵消扩散作用的确定的内
建电场;而在耗尽层近似下,空间电荷主要是电离杂质中心所提供的电荷,故在掺杂浓度一定时,一定的空间电荷也就对应于一定的势垒厚度。如果提高掺杂浓度,则就增大了电离杂质中心的浓度,即增大了空间电荷密度,于是在保持空间电荷总量大致一定的情况下,就将使得势垒厚度变薄。
相反,如果降低半导体的掺杂浓度,则势垒厚度增大。极端地,当两边半导体都成为本征半导体时,那么势垒厚度就将变为无穷大,这时p-n结实际上也就转变为一整块本征半导体了,p-n结消失。
【推论1】隧道结:当两边半导体的掺杂浓度很高(简并)时,则势垒厚度将很薄。如果掺杂浓度提高到使得势垒厚度薄至de Broglie波长大小时,那么p-n结两边的载流子就可以借助于量子隧道效应而穿过势垒区(不再受到势垒高度的限制),从而能够产生较大的电流,并且两个方向的电流都较大。这时,p-n结实际上也就变成了所谓隧道p-n结。
【推论2】金属的接触电势差:在两边掺杂浓度非常高(强简并)的极端情况下,就近似为两块金属之间的接触,这时势垒厚度也就减薄到接近Debye屏蔽长度的大小,内建电势差也就成为了金属之间的接触电势差(等于未接触前两边Fermi能级之差)。
【推论3】单边结:如果p-n结两边的掺杂浓度不一样,则两边的势垒厚度也将不同:因为空间电荷区中的正电荷与负电荷的数量总是相等的,若两边的电荷密度不一样,那就必然厚度不同。掺杂浓度较高一边的势垒厚度较薄,较低一边的势垒厚度则较厚;因此,若p型半导体的掺杂浓度很大(简并,记为p+),而n型半导体的掺杂浓度较低,那么整个p-n结的势垒厚度基本上也就是n型半导体一边的势垒厚度,这种p-n结特称为单边结(p+-n结)。
【推论3】Ohm接触:对于单边结,如果把高掺杂一边的半导体更换为金属,就成为了所谓金属-半导体接触,这也就相当于把高掺杂半导体一边的杂质浓度提高到接近金属导电的程度。所以,金属-半导体接触的势垒就完全处在半导体一边;势垒厚度基本上也就决定于半导体的掺杂浓度。这时,若提高半导体的掺杂浓度,使得势垒厚度变得很薄,以至于接近de Broglie波长,那么这种金属-半导体接触两边的载流子即可借助于隧道效应而顺利地穿过接触势垒,从而两个方向的电流都可以很大,即这种金属-半导体接触具有Ohm导电的特性,实际上也就成为了所谓Ohm接触。
半导体元器件在制作金属电极时,往往就利用了这种Ohm接触的特性。例如,对于BJT的三个电极:因为发射区掺杂浓度很高,所以把金属电极直接接触上去即可;基区表面的掺杂浓度也往往较高,金属电极直接与它接触,也可以成为Ohm接触;但是集电区的掺杂浓度往往较低,把金属电极直接与它接触的话,就不能获得Ohm接触,则必需事先要扩散一个高浓度的区域,才能获得Ohm接触。
【推论4】pin结的势垒厚度:在耗尽层近似下,若在p-n结的势垒区中人为地
加进去一个本征半导体层——i型层(完全的耗尽层),这就相当于把势垒区有意地增大了,这时势垒区即为整个i型层加上两边的空间电荷层——主要是i型层。因此,pin结的势垒厚度可近似为一个恒定值:基本上不随掺杂浓度和温度等的变化而变化。
(2)为什么p-n结势垒高度随着掺杂浓度的提高而增大?
——可以从两个角度来说明:①因为提高掺杂浓度时,势垒厚度将减薄,则在内建电压基本不变的情况下,势垒区中的内建电场必将增强,所以势垒高度也就必将增大。②从p-n结的能带图来看,因为提高半导体掺杂浓度时,n型半导体的Fermi能级就移近导带底,p型半导体的Fermi能级就移近价带顶,则两边半导体的Fermi能级之差增大了,所以势垒高度也就将随着掺杂浓度的提高而增大。
注意:在掺杂浓度提高时,势垒高度将增大,而势垒厚度是减小的!
【推论1】对于非简并半导体的p-n结,因为两边的Fermi能级都处于禁带之内,所以势垒高度(等于两边Fermi能级之差)将小于禁带宽度;但是,当掺杂浓度很高(简并)时,p-n结两边半导体的Fermi能级将进入能带内,这时的势垒高度将大于禁带宽度,隧道p-n结就是这种情况。
【推论2】如果降低p-n结两边半导体的掺杂浓度,则势垒高度将降低(但势垒厚度将增大)。特别,当两边半导体都降低为本征半导体时,则势垒高度降低为0,势垒厚度也变为无穷大,这时p-n结也就退化为一个高阻的电阻了。
(3)为什么温度升高时,p-n结的势垒高度将降低、势垒厚度将变薄?
——对于势垒高度:因为温度升高时,n型和p型半导体的Fermi能级都将移向禁带中央,即两边半导体的Fermi能级之差将会减小,所以从p-n结的能带图即可见到,势垒高度将会随之降低。
——对于势垒厚度:因为温度升高时,p-n结的势垒高度降低,即接触电势差减小,内建电场减弱,所以势垒厚度将会随之减薄
PN结原理: P-N 结的正向和反向特性
(1)为什么p-n结的正向电流很大?并且往往主要是少数载流子电流?
——在热平衡时,p-n结的内建电场正好阻挡着两边载流子的净转移,保持着动
态平衡,则没有电流通过。若在p-n结上外加一个正向电压(p端接正,n端接负)时,由于p-n结的势垒区可以近似为耗尽层,相当是一种高阻区,则外加电压将降主要降落在势垒区之上,而正向电压在势垒区中所产生的电场的方向正好与内建电场的方向相反,则削弱了内建电场,从而p型半导体中的空穴和n型半导体中的电子就将会向对方一边转移;空穴进入到n型半导体中、以及电子进入到p型半导体中之后,都属于少数载流子,则将在势垒区外、扩散区边缘处积累、并形成浓度梯度,然后借助于扩散作用而向前(半导体内部)运动,从而形成正向电流——少数载流子扩散电流。
注意:少数载流子扩散电流的大小只与扩散区两边的少数载流子浓度梯度有关,而与势垒区中的状况无关。因为只有少数载流子才能积累起浓度梯度,所以正向扩散电流也就只是少数载流子才能产生出来。
——从p-n结的能带来看,外加正向电压削弱内建电场的效果,也就相当于降低了势垒高度;外加正向电压越大,势垒高度就降低得越多(大致有正比关系)。而势垒高度的降低,就将有大量的空穴越过势垒而注入到n型半导体中、以及大量的电子越过势垒而注入到p型半导体中,并在扩散区头部积累、形成一定的浓度梯度,从而造成少数载流子扩散的正向电流。由于载流子越过势垒的过程,在能量上需要遵从Boltzmann分布规律,所以能够越过势垒的载流子浓度与势垒高度之间有指数函数关系,亦即注入的少数载流子浓度与外加正向电压之间有指数函数关系;而少数载流子扩散电流与注入到势垒边缘的少数载流子浓度本身成正比,所以p-n结的正向电流也将随着外加正向电压的升高而指数式增大,在不是高的正向电压下即可通过很大的电流——正向导电。
【推论1】复合电流:由于在正向电压很低时,p-n结势垒高度降低微小,则通过的少数载流子扩散电流就将很小,这时若势垒区中存在着一定数量的复合中心,那么这些复合中心就将导致产生一定的电流——复合电流,这些复合电流就有可能大于少数载流子的扩散电流。而对于Si p-n结等,势垒区中复合中心的作用往往不可忽略,因此在很低的正向电压下,通过p-n结的正向电流将主要是复合中心的复合电流。这种复合电流的特点是:电流的大小与复合中心浓度和势垒厚度成正比;与正向电压也有指数函数的关系,但是上升的速度(即正向伏安特性曲线的斜率)较小一些,并且与温度的关系也要弱一些。
注意:通过p-n结的正向电流共有两个成分,即扩散电流和复合电流。一般,复合电流很小,只有在很低正向电压、扩散电流很小时才起主要作用;在较大正向电压时,以扩散电流为主。可以想见,如果增大势垒区中复合中心的数量(可以通过增大复合中心浓度和增宽势垒厚度来实现),那么复合电流及其作用也就必将增大;此外,禁带宽度越大,因为扩散电流的成分就越小,则复合电流的成分也将越大。
【推论2】pin结的正向电流: pin结实际上是一种势垒厚度非常大的p-n结,它的空间电荷是分布在i型层以外两边的边缘处,整个i型层都是势垒区(有内建电场,是耗尽层);因此复合电流成分往往大于扩散电流,所以pin结的正向电流主要是复合电流——电流与电压有指数函数关系,但是电流增大的速度小于
扩散电流的指数函数关系。
【推论3】p-n结正向电流的温度关系:值得注意,虽然p-n结在很低正向电压时的正向电流主要是复合电流,但是,实际上不管正向电压的高与低,p-n结正向电流与温度的关系都将主要决定于扩散电流的温度关系,而与复合中心无关。这是由于少数载流子扩散电流随温度的变化较大一些的缘故(对Si p-n结,在室温附近和在0.6V正向电压时,温度每增加10K时,正向扩散电流约增加一倍),所以p-n结的正向电流随温度的变化主要是少数载流子扩散电流成分的变化,即正向电流具有正的温度系数。也正因为如此,p-n结的正向电压的温度变化率才存在有一个固定的数值:Si p-n结正向电压的温度变化率约为–2mV/K,Ge p-n结正向电压的温度变化率约为–1mV/K。
【推论4】在正向电压很大时:p-n结势垒高度较低,则通过的扩散电流很大,往往会出现所谓大注入情况,这时外加电压将有少量降落在材料电阻和接触电阻之上,于是使得电流随电压上升的速度下降;当正向电压大到使得势垒高度变得近似为0时,那么p-n结也就完全失去了其基本特点,变成了一个纯粹具有电阻特性的结构。
(2)为什么p-n结的反向电流很小?为什么少数载流子在反向电流中往往起着重要的作用?
—— p-n结的反向电流包含有两个成分:少数载流子扩散电流和复合中心产生电流。并且这两种成分的电流随电压和温度变化的规律有所不同。
①扩散电流:当外加反向电压时,因为反向电压所产生的电场与内建电场的方向相同,则使得势垒区中的总电场得以增强,从而阻挡载流子向对方转移的作用增大,即p-n结的势垒高度升高,于是就不可能有少数载流子注入,所以也就没有正向的少数载流子扩散电流。但是,由于势垒区中电场的抽取作用而使得在扩散区边缘处的少数载流子浓度变为0,则体内的平衡少数载流子即将向势垒区边缘输运、并形成浓度梯度,从而就有少数载流子借助于扩散作用而进入势垒区,并被电场拉向对方一边,结果形成反向电流;可见,这种反向电流也将要受到扩散区两边浓度梯度、即扩散作用的限制,因此在性质上它也是一种少数载流子扩散电流。
然而,因为半导体中的平衡少数载流子浓度总是很小(特别是掺杂浓度较高时),所以在扩散区两边形成的浓度梯度就必将很小,从而产生的反向扩散电流也就必定很小。这就给出了p-n结的单向导电性。
这种反向扩散电流具有两个重要的特点:
a)是所谓饱和电流:不管反向电压的高低,在扩散区边缘处的少数载流子浓度将始终为0。因为反向电压的高低,只是改变势垒区中的电场强度,而并不会改变扩散区边缘处少数载流子浓度为0的状态,所以也就不能改变扩散区两边的少数载流子浓度梯度,从而也就不能改变少数载流子的反向扩散电流,因此反向扩
散电流与反向电压无关,即这种反向电流是一种所谓饱和的电流——反向饱和电流。
b)正比于平衡少数载流子浓度:由于扩散区两边的浓度梯度近似地就等于平衡少数载流子浓度(令为线性分布,而且边缘处的少数载流子浓度总是0),所以反向扩散电流将与平衡少数载流子浓度成正比,即反向扩散电流将正比于本征载流子浓度的平方(因为npo=ni2/nno≈ni2/Ndo∝ni2[p型半导体],pno=ni2/ppo≈ni2/Nao∝ni2[n型半导体])。而本征载流子浓度与温度之间存在着指数函数的关系,所以反向扩散电流也将随着温度的升高而指数函数式增大。
②产生电流:在反向电压下,势垒区中的复合中心同样也将起着很大的作用,即出现产生电流。因为这时势垒区处于载流子严重欠缺的非平衡状态,则为了恢复平衡,其中的复合中心就表现为产生载流子的产生中心,产生出大量的电子和空穴;并且电子即被电场拉向n型半导体一边、空穴即被电场拉向p型半导体一边,从而就形成了反向电流。对于Si p-n结,这种反向产生电流的大小往往要大于反向扩散电流,因此产生电流对Si p-n结反向电流的贡献是主要的(对于Ge p-n结则否,那里是反向扩散电流为主)。
反向产生电流具有以下两个特点:
a)不是饱和电流;因为电流与势垒区中(包括势垒区表面)的产生中心的数量有关,而势垒厚度会随着反向电压的增大而展宽,所以产生中心的数量也将随着反向电压的增大而增多,于是反向产生电流也就不会饱和——电流与电压有关。
b)因为产生电流主要决定于势垒区中产生中心的数量,所以反向产生电流与温度的关系不大。然而由于反向扩散电流与温度之间存在着指数函数的关系,因此,尽管Si p-n结的反向电流在大小上主要是产生电流,但是反向电流在与温度的关系上则基本上决定于其中扩散电流成分随温度的变化,即反向电流具有较大的正温度系数。对Si p-n结,在室温附近每增加1℃,反向电流就相对增加15%,即每增加6℃,反向电流就增加一倍,这种变化率就是由于反向扩散电流的温度关系所致。
【推论1】半导体工艺:p-n结的反向电流大小是一个重要的性能指标。为了减小反向电流,除了适当提高两边的掺杂浓度(以降低反向扩散电流)以外,最重要的问题是要减少势垒区内部和表面的复合中心(以降低反向产生电流)。因为复合中心主要来自于杂质和缺陷,所以减小反向电流的具体措施有如:a)注意工艺清洁度,避免有害杂质的引入;b)注意工艺完美性,避免产生工艺诱生缺陷;c)选取无缺陷和无有害杂质的半导体材料;d)表面保护和钝化。总之,p-n结的反向电流与材料和工艺的完美性有很大的关系。
【推论2】隧道击穿:p-n结在反向电压下,除了产生一定的反向电流以外,还会发生所谓击穿——反向电流突然增大的一种现象。如果:p-n结两边的掺杂浓度很高、以致势垒厚度薄至de Broglie波长时;又,如果反向电压使得p型半导
体价带中的价电子能量与n型半导体导带电子的能量相当时,那么,p型半导体价带中的大量价电子就可以借助于量子隧道效应,而直接隧穿到n型半导体的导带中去,从而形成很大的反向电流——反向隧道电流,这就是所谓p-n结的隧道击穿。
隧道击穿的特点:a)只有在势垒厚度很薄、简并的p-n结中才能出现;b)发生隧道击穿的反向电压很低(对于Si p-n结,一般低于5V);c)隧道击穿电压具有负的温度系数:因为半导体禁带宽度将随温度的升高而变窄,这就使得p-n结势垒厚度变得更薄,所以隧道击穿电压降低。
【推论3】雪崩击穿:如果p-n结两边的掺杂浓度不是很高,则势垒厚度较大,这时在反向电压增大到很大时,也有可能发生击穿——雪崩击穿现象。因为高电场会使得势垒区中的个别载流子获得很大的动能,当一个载流子的动能达到约半导体禁带宽度的1.5倍时,就可以把价带中的一个价电子激发出来,即产生出一个电子-空穴对,而这些电子和空穴又被加速、获得能量,并进一步激发出新的电子-空穴对来,如此继续下去,即可很快地产生出大量的电子-空穴对,同时电子被势垒区中的电场拉向n型半导体一边,空穴被势垒区中的电场拉向p型半导体一边,从而形成很大的反向电流,即为雪崩击穿。
雪崩击穿的特点:
a)雪崩击穿只有在势垒厚度较大的非并p-n结中才会出现。因为若势垒太薄的话,载流子在电场加速下就不可能获得足够的动能,则难以达到雪崩击穿所需要满足的能量条件(即动能约为半导体禁带宽度的1.5倍),但这时容易发生隧道击穿。
b)雪崩击穿存在一个临界电场:这是由于雪崩击穿需要满足一个能量条件(即动能约为半导体禁带宽度的1.5倍),这只有在电场较强、载流子漂移一定距离后才能实现,所以发生雪崩击穿的反向电压都较高(对于Si p-n结,一般高于6V),而且势垒厚度也较大。可见,对于较大势垒厚度的p-n结,只要势垒区中某个局部的电场达到了临界击穿电场的话,那么就会发生雪崩击穿,因此提高雪崩击穿电压的重要措施就是:改善势垒区中电场分布的均匀性和降低最大电场。
c)击穿电压具有正的温度系数:因为温度升高时,载流子遭受散射的几率增大,使得平均自由程减短,则导致较难以达到雪崩击穿的能量条件,从而击穿电压提高。
d)禁带宽度越大,载流子需要获得更大的动能才能达到雪崩击穿的能量条件,所以击穿电压也就越高。
e)在势垒厚度不是非常薄的情况下,半导体掺杂浓度越高,势垒厚度就越小,电场也就越强,则就越容易达到临界击穿电场,所以雪崩击穿电压下降
-
个人进修总结
一个学期过去了,在这个学期里我感受到自己教学任务的之重。特别是随着经济的发展,人民生活水平的提高,下一代的生活方式、思想也逐渐发生…
-
住院患者护理服务满意度调查分析总结[1] 3
20xx年第一季度护理服务质量满意度调查总结本季度护理部满意度调查采取定点访问和发放问卷相结合的形式,以科室为单位,共5个护理单元…
-
信息技术期末教学工作总结
李海霞本学期我们即担任四年级和五年级的信息技术教学,又承担学校机房的管理工作,通过一学期的努力,我们按时并圆满地完成了教学任务。回…
-
统计年度工作总结
20xx年对我公司来说是具有重大历史意义的一年,在这一年中,公司完成了搬迁、复产、认证工作,工作量之大是不言而喻的。我车间是拥有近…
-
优质课评选活动总结
仙水小学20xx~20xx学年度下期优质课评选活动总结本期开展的优质课评选活动,在各教研组、各备课组的精心组织和大力支持下,通过各…