半导体实验报告1
半导体物理实验报告

实验一 半导体的霍尔效应
实验目的
1、了解霍尔效应实验原理以及有关霍尔器件对材料要求的知识。
2、学习用“对称测量法”消除副效应的影响,测量试样的VH-IS和VH-IM曲线。
3、确定试样的导电类型、载流子浓度以及迁移率。
实验仪器
霍尔效应实验组合仪
实验步骤
⑴ 开关机前,测试仪的“IS调节”和“IM调节”旋钮均置零位(即逆时针旋到底)。
⑵ 按图1.2 连接测试仪与实验仪之间各组连线。注意:①样品各电极引线与对应的双刀开关之间的连线已由制造厂家连接好,请勿再动!②严禁将测试仪的励磁电源“IM输出”误接到实验仪的 “IS输入”或“VH、 输出”处,否则,一旦通电,霍尔样品即遭损坏!样品共有三对电极,其中A、A/或C、C/用于测量霍尔电压
输出”处,否则,一旦通电,霍尔样品即遭损坏!样品共有三对电极,其中A、A/或C、C/用于测量霍尔电压 ,A、C或A/、C/用于测量电导,D、E为样品工作电流电极。样品的几何尺寸为:d=0.5mm ,b=4.0mm ,A、C电极间距l=3.0mm。仪器出产前,霍尔片已调至中心位置。霍尔片性脆易碎,电极甚细易断,严防撞击,或用手去摸,否则,即遭损坏! 霍尔片放置在电磁铁空隙中间,在需要调节霍尔片位置时,必须谨慎,切勿随意改变y轴方向的高度,以免霍尔片与磁极面磨擦而受损。
,A、C或A/、C/用于测量电导,D、E为样品工作电流电极。样品的几何尺寸为:d=0.5mm ,b=4.0mm ,A、C电极间距l=3.0mm。仪器出产前,霍尔片已调至中心位置。霍尔片性脆易碎,电极甚细易断,严防撞击,或用手去摸,否则,即遭损坏! 霍尔片放置在电磁铁空隙中间,在需要调节霍尔片位置时,必须谨慎,切勿随意改变y轴方向的高度,以免霍尔片与磁极面磨擦而受损。
⑶ 接通电源,预热数分钟,电流表显示“.000”( 当按下“测量选择”键时 )或“0.00”(放开“测量选择”键时),电压表显示为“0.00”。
⑷ 置“测量选择”于IS挡(放键),电流表所示的值即随“IS调节”旋钮顺时针转动而增大,其变化范围为0-10mA,此时电压表所示读数为“不等势”电压值,它随IS增大而增大,IS换向,VH极性改号(此乃“不等势”电压值,可通过“对称测量法”予以消除)。




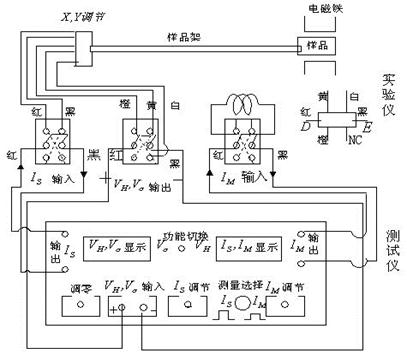
图1.2 实验线路连接装置图
⑸ 置“测量选择”于IM挡(按键),顺时针转动“IM调节” 旋钮,电流表变化范围为0-1A。此时 值随IM增大而增大,IM换向,VH极性改号(其绝对值随IM 流向不同而异,此乃副效应而致,可通过“对称测量法”予以消除)。至此,应将“IM调节”旋钮置零位(即逆时针旋到底)。
值随IM增大而增大,IM换向,VH极性改号(其绝对值随IM 流向不同而异,此乃副效应而致,可通过“对称测量法”予以消除)。至此,应将“IM调节”旋钮置零位(即逆时针旋到底)。
⑹ 放开测量选择键,再测 ,调节
,调节 ,然后将“
,然后将“ 输出”切换开关倒向
输出”切换开关倒向 -侧,测量
-侧,测量 电压(
电压( 电极间电压);
电极间电压); 换向,
换向, 亦改号。这些说明霍尔样品的各电极工作均正常,可进行测量。将“
亦改号。这些说明霍尔样品的各电极工作均正常,可进行测量。将“ 输出”切换开关恢复
输出”切换开关恢复 一侧。
一侧。
实验数据及处理
下表 IM=0.0600A IS取值范围为1.00-4.00mA
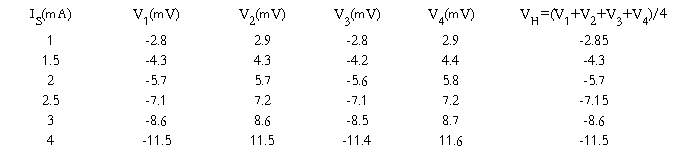
1、测绘VH-IS曲线
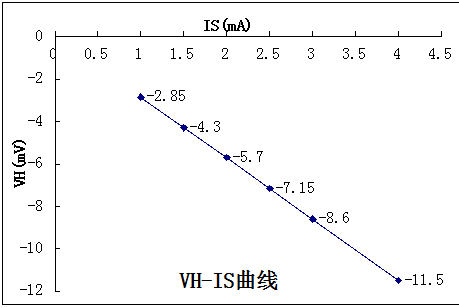
下表 IS=3.00mA IM的取值范围为0.300-0.800A
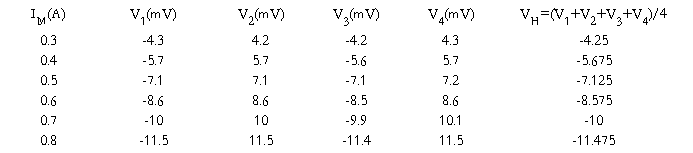
2、测绘VH-IM曲线
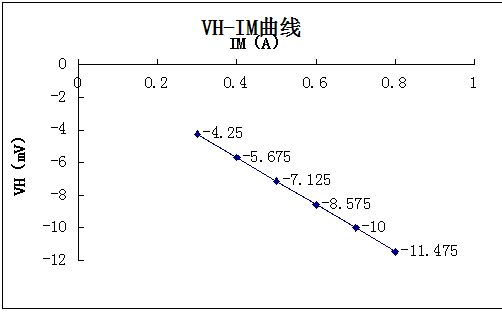
3、测量Vσ值
在IM=0时,取IS=0.25mA,测得Vσ=-18.85mV
4、确定样品导电类型
取IS=0.25mA,IM=0.6A,测得VA’A=-0.06mV
5、求样品的RH、n、σ、μ
RH=VHd/ISB*108=6.75*103(厘米3/库伦)
n=1/(|RH|e)=9.23*1014/cm3
σ=neμ=21(S/M)
μ=|RH|σ=1.41*103
实验二 半导体PN结的物理特性及弱电流测量
实验目的
1、在温室时,测量PN结电流与电压的关系
2、在不同温度条件下,测量PN结电流与电压关系并计算玻尔兹曼常数
3、掌握用运算放大器组成电流—电压变换器测量弱电流的方法
实验仪器及材料
1、PN结物理特性测定仪
2、测试电路
3、保温杯级温度计
实验原理
PN结物理特性及玻尔兹曼常数测量
由半导体物理学可知,PN结的正向电流-电压关系满足:
 (2-1)
(2-1)
式(2-1)中I是通过PN结的正向电流, 是不随电压变化的常数,T是热力学温度,e是电子电量,U为PN结的正向压降。由于在常温(300K时),kT/e
是不随电压变化的常数,T是热力学温度,e是电子电量,U为PN结的正向压降。由于在常温(300K时),kT/e  0.026V,而PN结正向压降约为十分之几伏,则
0.026V,而PN结正向压降约为十分之几伏,则  》1,(2-1)式括号内1完全可以忽略,于是有:
》1,(2-1)式括号内1完全可以忽略,于是有:
 (2-2)
(2-2)
即PN结正向电流随正向电压按指数规律变化。若测得PN结I-U关系值,则利用(2-2)式可以求出e/KT。在测得温度T后,就可以得到e/K常数,把电子电量作为已知值代入,即可求得玻尔兹曼常数K。
在实际测量中,二极管的正向I-U关系虽然能较好满足指数关系,但求得的常数K往往偏小。这是因为通过二极管电流不只是扩散电流,还有其它电流。一般包括三个部分:〔1〕扩散电流,它严格遵循(2-2)式;〔2〕耗尽层复合电流,它正比于 ;〔3〕表面电流,它是Si和
;〔3〕表面电流,它是Si和 界面中杂质引起的,其值正比于
界面中杂质引起的,其值正比于 ,一般m>2。因此,为了验证(2-2)式及求出准确的e/K常数,不宜采用硅二极管,而采用硅三极管接成共基极线路,因为此时集电极与基极短接,集电极电流中仅仅是扩散电流。复合电流主要在基极出现,测量集电极电流时,将不包括它。本实验中选取性能良好的硅三极管(TIP41型),实验中又处于较低的正向偏置,这样表面电流影响也完全可以忽略,所以此时发射极电流与结电压将满足(2-2)式。实验线路如图2.1所示。
,一般m>2。因此,为了验证(2-2)式及求出准确的e/K常数,不宜采用硅二极管,而采用硅三极管接成共基极线路,因为此时集电极与基极短接,集电极电流中仅仅是扩散电流。复合电流主要在基极出现,测量集电极电流时,将不包括它。本实验中选取性能良好的硅三极管(TIP41型),实验中又处于较低的正向偏置,这样表面电流影响也完全可以忽略,所以此时发射极电流与结电压将满足(2-2)式。实验线路如图2.1所示。
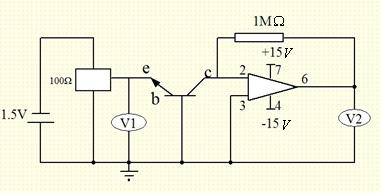
图2.1 实验线路图
实验数据及处理
下表为实验实测数据

下图是以U1为横坐标,lnU2为纵坐标画出的图

在45°C时,当U1>0.40时,扩散电流到达饱和状态,所以舍去了。
根据图表,算得斜率b=36.19
计算玻尔兹曼常数:
k=e/(b*T)=1.490*10-23
实验三 PN结电容的测量
实验目的
1、了解p-n结电容随外加电压变化的一般规律。
2、了解单边突变结或线性缓变结中的势垒电容与外加反偏电压的关系。
3、掌握用高频Q表测量反向偏压下晶体管p-n结电容的原理与方法
实验目的
p-n结电容随外加电压的变化规律
p-n结势垒电容的实质是,当p-n结外加正向偏压增加(或反向偏压减小)时,势垒区宽度变窄,空间电荷数量减少。因为空间电荷由不能移动的杂质离子组成,所以空间电荷的减少是由于n区的电子和p区的空穴过来中和了势垒区中的电离施、受主离子,即将一部分电子和空穴“存入”势垒区。反之,当p-n结外加正向偏压减小(或反向偏压加大)时,势垒区变宽,空间电荷数量增加。这就意味着有一部分电子和空穴从势垒区中“取出”。这种载流子在空间电荷区中的“存入”和“取出”,如同一个
平行板电容器的充电与放电。不同的是,p-n结空间电荷区宽度随外加电


 压变化,示意图如图3.1。
压变化,示意图如图3.1。

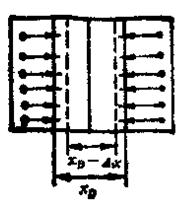
图3.1 p-n结势垒电容
由半导体物理可知,对于单边突变结,若p-n结面积为A,则势垒电容
 (3-2)
(3-2)
式中  --- p-n结轻掺杂一侧杂质浓度;
--- p-n结轻掺杂一侧杂质浓度;
 ---半导体介电常数;
---半导体介电常数;
 ---真空介电常数。
---真空介电常数。
对于线性缓变结有  (3-3)
(3-3)
式中  ---杂质浓度梯度。
---杂质浓度梯度。
从式(3-2)和(3-3)看出,突变结势垒电容和结的面积及轻掺杂一侧杂质浓度有关,线性缓变结势垒电容与结面积及杂质浓度梯度有关。为了减小势垒电容,可以减小结面积和轻掺杂一侧杂质浓度或杂质浓度梯度。另外,从公式还可看出,势垒电容正比于 或
或 。这说明反向偏压越大,则势垒电容越小。
。这说明反向偏压越大,则势垒电容越小。
p-n结扩散电容指的是p-n结外加正向偏压时,电子和空穴在p区和n区中形成非平衡载流子的积累。当正向偏压增加时,在扩散区中积累的非平衡载流子也增加,即n区扩散区内积累的非平衡空穴和与之保持电中性的电子以及P区扩散区中积累的非平衡电子和与之保持电中性的空穴均增加,导致扩散区内电荷数量随外加电压变化,形成扩散电容,扩散电容随正向偏压按指数关系增长。
在反向偏压或小的正向偏压作用下,以势垒电容为主;在大的正向偏压作用下,以扩散电容为主。
本实验主要测晶体管结电容在反向偏压作用下的电容变化值,故以势垒电容为主。
实验数据处理
下表为实验实测数据

下图为晶体二极管的C-V图
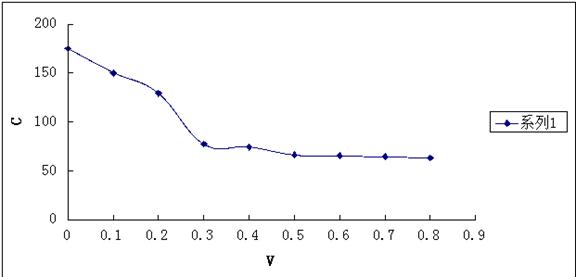
下图为晶体三极管的C-V
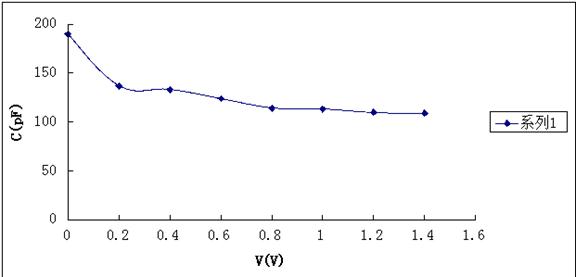
由于实验做的只是本实验的部分内容,所以只对做过实验的进行讨论
思考题
何谓p-n结势垒电容?
答:结电容就相当于并联在两个结的一个电容,是由于pn结的面积形成的一个电容。在积累空间电荷的势垒区,当PN结外加电压变化时,引起积累在势垒区的空间电荷的变化,即耗尽层的电荷量随外加电压而增多或减少,这种现象与电容器的充、放电过程相同。耗尽层宽窄变化所等效的电容称为势垒电容。
实验四 四探针法测半导体材料电阻率及方块电阻
实验目的
1、了解SDY-4型探针测试仪的性能及使用方法。
2、掌握四探针法测量半导体材料电阻率及方块电阻的方法。
3、了解影响测试精度的诸因素。
实验主要仪器设备和材料
SDY-4型探针测试仪;被测硅片。
实验原理
测量电阻率
设一半导体单晶材料,其大小与厚度相对于探针之间的距离可视为半无限大,四极探针在一直线上且间距相等,探针与样品成点接触。电流从点1流入,从点4流出,如图4.1所示。



测量厚度小于S/2的有限大小的圆片,关系式为:
ρ=W*V*C/I
式中W为厚度(本实验为4.8mm)。在实测中:
C=F(W/S)*F(D/S)*FSP
即 ρ=(V/I)*W*F(W/S)*F(D/S)*FSP
其中:D为样品直径;本实验样品D=52.36mm
S为平均探针间距;本实验样品S=1.002mm
W为样品厚度;本实验样品W=4.8mm
FSP为探针的修正系数;本实验样品FSP=1.001
F(W/S)查表得为0.998
F(D/S)查表得为,中心4.517,半径中心4.505,边缘4.47;
I为1,4探针流过的电流
V为2,3探针尖取出的电压值
实验步骤
A、检查样品是否符合要求
B、测量薄圆片的电阻率ρ
C、根据公式,测出相应的参数后带入公式,算出C值
D、把样品置于探针仪台上,旋转螺丝使探针与硅片接触
E、按K6键,使电流指示灯亮,调节旋钮W1,W2,使电流显示与C*W的值相等,那么CW/I=1
F、根据公式就有ρ=V。再按K6电压指示灯亮,再按K5则显示器上显示的为电阻率。
实验数据

出现误差的原因可能是因为硅片表面被污染,或者实验仪器测试是出现的误差,比如数据读取时出现偏差。
思考题
在测量半导体材料电阻率时,为什么要求待测面平整、粗糙而不是抛光如镜?
答:因为在采用四探针法测量电阻率时,金属探针不能与半导体形成整流接触,故打毛表面以破坏肖特基势垒的作用。只有表面平整,才能较好地满足四探针技术的要求,以使测量准确。
实验五 少子寿命及硅缺陷的观察
实验目的
1、掌握用光电导衰减法测量半导体材料少子寿命的基本原理和实验方法,加深对少子寿命及其样品其他物理参数关系的理解。
2、掌握金相显微镜的使用方法,并通过对给定硅样品的观察,学会识别常见缺陷的腐蚀图形。
实验仪器及材料
1、双踪示波器;
2、DSY-II型单晶寿命测试仪;
3、金相显微镜一台;
4、待测硅样品若干;
内容一:半导体材料少子寿命的测量
实验原理
在测量非平衡少数载流子寿命的各种实验方法中,都需要用某种方式在样品中产生非平衡少子。光电导衰减法是用光注入的方式产生非平衡少子从而导致样品电导率的改变为其基本测量依据。
用适当波长的光照射半导体样品,当光子能量大于禁带宽度时,一部分价带电子被激发到导带,于是在导带和价带中分别产生了非平衡的电子和空穴,热平衡状态受到破坏。这种产生非平衡截流子的方法即为光注入法。在小注入和不存在陷阱的情况下,可以认为非平衡少子浓度Δp(假设为n型样品)与非平衡多子浓度Δn相等。样品电导率的增加与少子浓度的关系为
 (5-1)
(5-1)
式中q为电子电量, 分别为空穴和电子的迁移率。当去掉光照后,非平衡少子浓度Δp将按指数规律衰减,即
分别为空穴和电子的迁移率。当去掉光照后,非平衡少子浓度Δp将按指数规律衰减,即
 (5-2)
(5-2)
式中t为衰减时间, 为衰减时间常数。因而附加电导率
为衰减时间常数。因而附加电导率 也按指数规律衰减:
也按指数规律衰减:
 (5-3)
(5-3)
式(5-2)和(5-3)中的 即为少子寿命。其物理意义是在光照消失后,非平衡少子在复合前平均存在的时间。
即为少子寿命。其物理意义是在光照消失后,非平衡少子在复合前平均存在的时间。
在样品两端加一恒流源,假设在没有光照时样品压降为V0,因为通过样品的电流是恒定不变的,在光照时,由于样品的电导率的增加,样品压降改变ΔV,可以证明
ΔV≈-(v0/σ0)*Δσ (Δσ/σ<<1)
所以在去掉光照后,样品附加电压的变化也符合指数规律

在实验中测出电压的衰变时间τ,就相当于测出了少子的寿命。
电压的衰减曲线如图5.2所示。在实验中测出电压的衰变时间常数 ,就相当于测出了少子寿命。
,就相当于测出了少子寿命。

图5.1 光照半导体样品 图5.2
实验步骤
A、接上电源线以及用高频连接线将CZ与双踪示波器Y输入端接通,开启示波器;
B、将清洁处理后的样品置于电极上;(为提高灵敏度,在电极上涂抹一点自来水)
C、开启总电源KD预热15分钟,按下K接通脉冲电路电源
D、调整示波器电压及释抑时间,内同步,Y轴衰减X轴扫描速度及曲线的上下左右位置,是仪器输出的指数衰减光电导信号波形稳定下来,并与屏幕的标准曲线尽量吻合。
E、若偏离指数曲线,则作相应处理
F、根据所调的合适波形,找出时间常数τ
通过我们的调节,从双踪示波器上读出
τ=40ms
内容二:硅缺陷的观察
实验内容
1、了解金相显微镜的使用方法
2、将腐蚀好待观察的各种样品放在金属显微镜下观察,记下放大倍数,标定视场面积S
3、计算各种样本的位错密度。
金相显微镜结构

图6-1
1目镜 2、双目头 3、压片簧 4、方形载物台 5、物镜 6、视场光栏调节手柄 7、滤色片 8、孔径光栏调节手柄 9、灯箱 10、灯座固紧螺钉 11、灯炮调节手柄 12、聚光镜调节手柄 13、视场光栏调节骡钉 14、横向移动手轮 15、纵向移动手轮 16、微动调焦手轮 17、粗动调焦手轮 18、限位固紧手柄 19、镜筒固紧骡钉
实验原理
所谓金相腐蚀法就是将硅片通过一定的化学腐蚀,然后在金相显微镜下观察腐蚀坑形状,从而判断缺陷名称、计算缺陷密度。基本原理如下:硅片中有缺陷的地方,原子排列不规则,晶格完整性受到破坏,能量状态较不稳定,同时易聚集杂质,是晶格原子间键合力减弱,存在一定应力,因此对于某些特定的腐蚀剂,相对理想晶格,有缺陷的地方期腐蚀速度较大,在晶格表面显示出腐蚀坑。
位错
经腐蚀的硅单晶样品,在位错线与表面相交处显示出腐蚀凹坑。一个腐蚀凹坑代表一条位错线的露头处。不同的晶面腐蚀坑形状不同,(111)面位错腐蚀坑为正三角形,(100)面为正方形。图6-6示出了(111)面、(100)面位错腐蚀坑形状。


图6-6
晶体中位错的多少是用位错密度表征的,位错密度是指单位体积内位错线的总长度。在实验中是用金相显微镜观察确定面积内位错腐蚀坑的数目。若视场面积为S,视域内总腐蚀坑数为N,则位错密度为
ND=N/S(个/cm2) (6-1)
 (D为视场直径) (6-2)
(D为视场直径) (6-2)
实验数据及处理
实验中,提供金属显微镜观测到在直径9.2cm的圆圈中,有82个位错,当时使用的目镜为*10,物镜为*25,所以位错密度为:
ND=82/(π*9.22/4)*10*25=2838(个/cm2)
-
半导体制冷试验设计
半导体制冷实验实验题目半导体制冷实验实验目的1掌握半导体制冷的基本原理2实验设计半导体制冷系统3计算制冷系数KTcThTc4观察半…
-
半导体制冷实验
半导体制冷实验实验目的1了解帕尔帖效应和半导体制冷原理2学习半导体制冷特性和应用计算半导体制冷系统最大制冷系数3演示验证帕尔帖效应…
-
实验12 温度传感器特性和半导体制冷温控实验
实验12温度传感器特性和半导体制冷温控实验实验目的1了解半导体制冷和制热原理2测量NTC热敏电阻PTC热敏电阻及集成温度传感器的温…
-
半导体实验报告1
半导体物理实验报告实验一半导体的霍尔效应实验目的1了解霍尔效应实验原理以及有关霍尔器件对材料要求的知识2学习用对称测量法消除副效应…
-
半导体制冷演示效果实验
半导体制冷演示效果实验实验名称二级半导体制冷效果演示实验设备DC12V电源两片tec112706制冷片导冷模块散热片温度计5V风扇…
-
组原--2.半导体存储器实验报告
邮件报告日期940366193qqcom20xx1214指导教师姚杰万胜刚华中科技大学课程实验报告目录1234实验目的1实验设备1…
-
复旦大学 物理实验(上) 半导体PN结的物理特性实验报告
半导体PN结的物理特性实验目的与要求1学会用运算放大器组成电流电压变换器的方法测量弱电流2研究PN结的正向电流与电压之间的关系3学…
-
实验报告---半导体PN结的物理特性及弱电流测量
成都信息工程学院物理实验报告姓名石朝阳专业班级学号实验日期20xx915下午实验教室51021指导教师实验名称PN结物理特性综合实…
-
重庆邮电大学半导体工艺实习报告
半导体工艺认实实习实验课半导体工艺认知一前言经过四次八节半导体工艺认识实习课在老师的积极指导和同学们配合下我顺利的完成了本实验课程…
-
半导体制冷试验设计
半导体制冷实验实验题目半导体制冷实验实验目的1掌握半导体制冷的基本原理2实验设计半导体制冷系统3计算制冷系数KTcThTc4观察半…